显微红外热点定位测试系统 发布时间:2024-11-13 10:27:46
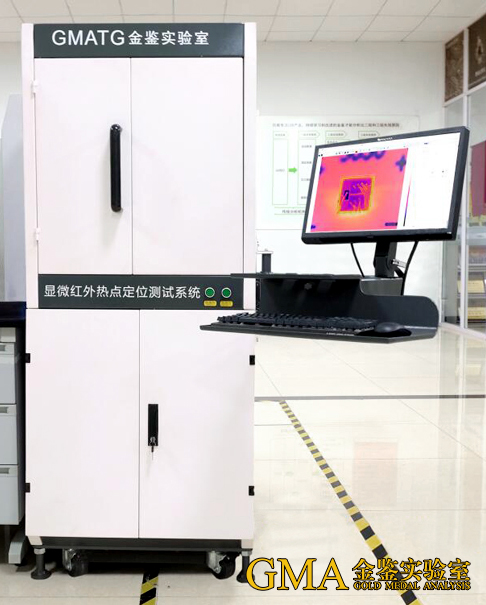
显微红外热点定位测试系统
半导体器件作为现代科技社会的一大进步,却因为各种原因停滞不前,其中半导体器件故障问题一直是行业内的热点问题,多种多样的环境因素,五花八门的故障形式,使得制造商不知所措,针对此问题,金鉴通过算法、芯片和图像传感技术的改进,打造出高精智能化的测试体系,专为电子产品FA设计,整合出一套显微红外热点定位测试系统,价格远低于国外同类产品,同样的功能,但却有更精确的数据整理系统、更方便的操作体系,正呼应了一句名言“最好的检测设备是一线的测试工程师研发出来的!”。
金鉴显微红外热点定位测试系统已演化到第四代:配备20um的微距镜,可用于观察芯片微米级别的红外热分布;通过强化系统软件算法处理,图像的分辨率高达5um,能看清金道与缺陷;热点锁定lock in功能,能够精准定位芯片微区缺陷;系统内置高低温数显精密控温平台与循环水冷装置校准各部位发射率,以达到精准测温度的目的;具备人工智能触发记录和大数据存储功能,适合电子行业相关的来料检验、研发检测和客诉处理,以达到企业节省20%的研发和品质支出的目的。
红外显微镜系统(Thermal Emission microscopy system),是半导体失效分析和缺陷定位的常用的三大手段之一(EMMI,THERMAL,OBIRCH),是通过接收故障点产生的热辐射异常来定位故障点(热点/Hot Spot)位置。
存在缺陷或性能不佳的半导体器件通常会表现出异常的局部功耗分布,最终会导致局部温度增高。金鉴显微热分布测试系统利用热点锁定技术,可准确而高效地确定这些关注区域的位置。热点锁定是一种动态红外热成像形式,通过改变电压提升特征分辨率和灵敏度,软件数据算法改善信噪比。在IC分析中, 可用来确定线路短路、 ESD缺陷、缺陷晶体管和二极管,以及器件闩锁。该测试技术是在自然周围环境下执行的,无需遮光箱。
金鉴显微红外热点定位测试系统优点:
高灵敏度的锁相热成像缺陷定位
配合电测,XRAY等对样品作无损分析
选配不同镜头,可分析封装芯片及裸芯片
对短路及漏电流等分析效果佳
0.03℃温度分辨率,20um定位分辨率,可探测uW级功耗
其他功能如真实温度测量,热的动态分析,热阻计算
相对于其他缺陷查找设备(EMMI,THERMAL,OBIRCH),价格可承受
与国外同类设备相比,金鉴显微红外热点定位测试系统优点显著:

金鉴显微红外热点定位测试系统 VS OBIRCH
OBIRCH广泛用于芯片级分析和中等短路电阻,但挑战性低于10欧姆
金鉴显微红外热点定位系统一般具有较高的成功率
金鉴显微红外热点定位系统可兼容大样品、微米级样品测试
金鉴显微红外热点定位系统热点锁定功能可以显着扩大覆盖范围,降低漏电阻
金鉴显微红外热点定位系统支持长期在线监测热点缺陷异常
金鉴显微红外热点定位系统测试依据:GB/T 28706-2012 无损检测
金鉴显微红外热点定位系统可以对探测电源、芯片等短路漏电故障缺陷
热点锁定(lock in)功能:温度最高点定位聚焦过程只需要一秒

应用领域:
PCBA短路热点失效分析、IC器件缺陷定位、升温热分布动态采集、功率器件发热点探测、集成电路失效分析、无损失效分析、细微缺陷探测、正向点亮漏电LED芯片,Vf偏低(左图)。反向测试芯片漏电流显示漏电流较大(右图)。
测试结果:显微红外热点定位热分布测试结果显示:漏电芯片上热分布不均,存在异常热点,热点即为芯片漏电缺陷点。
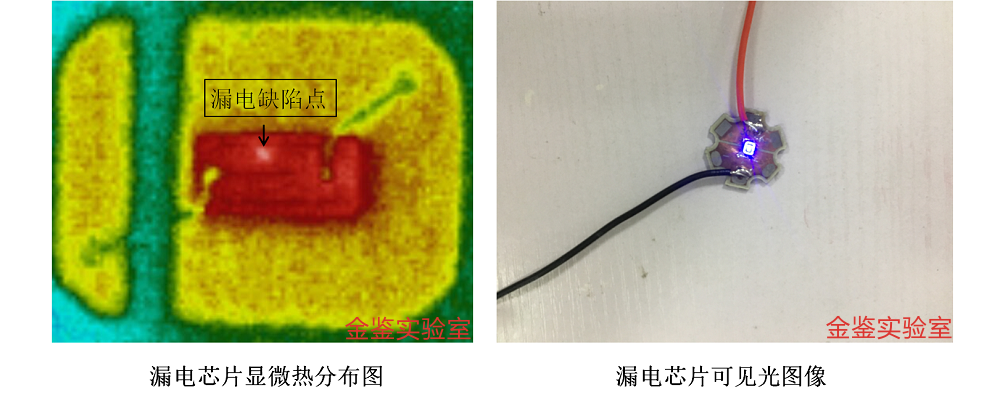
存在缺陷或性能不佳的半导体器件通常会表现出异常的局部功耗分布,最终会导致局部温度增高。金鉴显微红外热点定位热分布系统,利用新型高分辨率微观缺陷定位技术,可在大范围内高效而准确地确定关注区域(异常点)位置。图示为在金鉴显微红外热点定位测试布设备下LED芯片漏电图:

在金鉴显微红外热点定位测试系统中,不同模式调色板下的芯片漏电图如图所示显示:
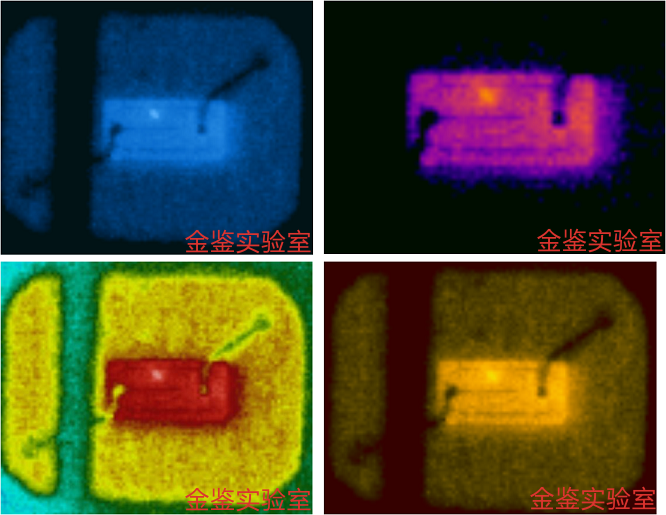
对于受损LED来说,缺陷引起的非辐射复合几率增加,在加压增强的情况下,局部的高电场或强复合所引起的红外辐射能量被金鉴显微红外探测系统所接收,可以看到明亮的发光点或者热斑,再经过CCD图像转换处理,将其与器件表面的光学发射像叠加,就可以确认漏电造成发光点的位置。可见光与红外双重成像技术精确定位细微缺陷!
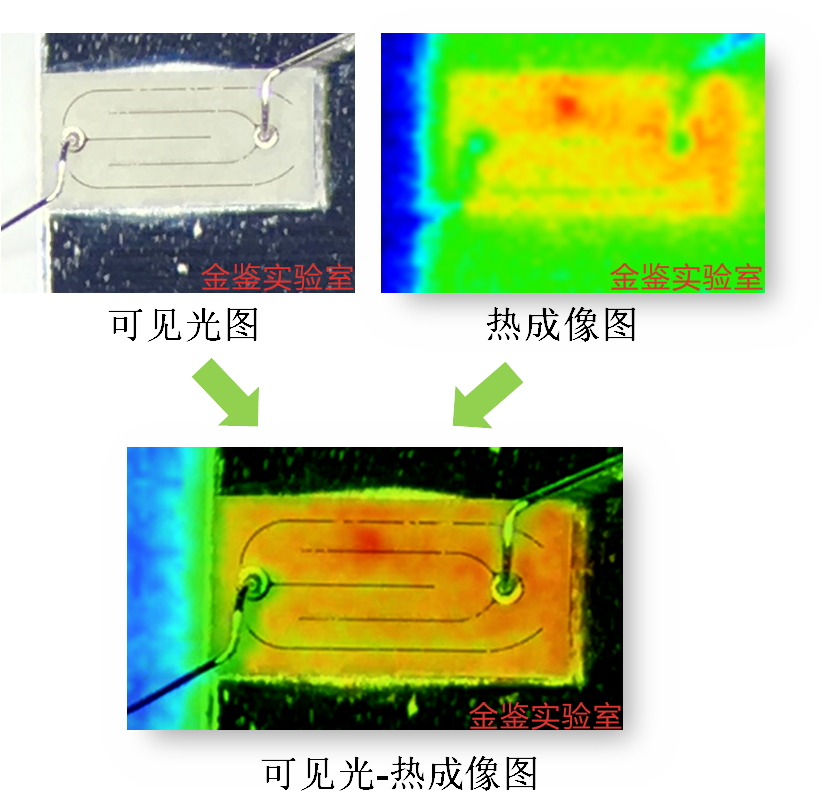
案例一:金鉴显微红外热点定位系统查找紫外垂直芯片漏电点
客户反馈其紫外垂直芯片存在漏电现象,送测裸晶芯片,委托金鉴查找芯片漏电点。
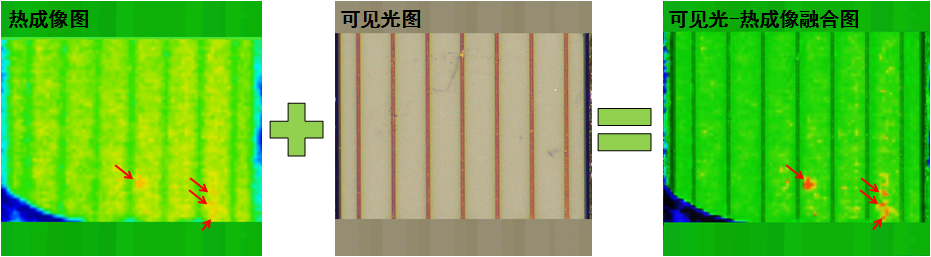
取裸晶芯片进行外观观察,发现芯片结构完整,无击穿形貌,表面干净无污染。通过金鉴探针系统对裸晶芯片加载反向电压后,在暗室中使用显微红外热点定位系统的热点自动搜寻功能定位到了芯片上若干热点。经过可见光与热成像双重成像融合后,可以清晰观察到热点所在,即为芯片漏电缺陷处。
案例二:客户送测LED芯片,委托金鉴在指定电流条件下(30mA、60mA、90mA)进行芯片热分布测试。
其中60mA为额定电流。
点亮条件:30mA、60mA、90mA
环境温度:20~25℃/40~60%RH

灯珠正常使用时,额定电流为60mA。金鉴通过显微热分布测试系统发现,该芯片在额定电流下工作,芯片存在发热不均匀的现象,其负极靠近芯片边缘位置温度比正电极周围高10度左右。建议改芯片电极设计做适当优化,以提高发光效率和产品稳定性。
该芯片不同电流下(30mA、60mA、90mA)都存在发热不均的现象,芯片正极区域温度明显高于负极区域温度。当芯片超电流(90mA)使用时,我们发现过多的电流并没有转变成为光能,而是转变成为热能。
案例三:
某灯具厂家把芯片封装成灯珠后,做成灯具,在使用一个月后出现个别灯珠死灯现象,委托金鉴查找原因。本案例,金鉴发现该灯具芯片有漏电、烧电极和掉电极的现象,通过自主研发的显微热分布测试仪发现芯片正负电极温差过大,再经过FIB对芯片正负电极切割发现正极Al层过厚和正极下缺乏二氧化硅阻挡层。显微热分布测试系统在本案例中,起到定位失效点的关键作用。
对漏电灯珠通电光学显微镜观察:
金鉴随机取1pc漏电灯珠进行化学开封,使用3V/50uA直流电通电测试,发现灯珠存在电流分布不均现象,负极一端处的亮度较高。

对漏电灯珠显微红外观察:
使用金鉴自主研发的显微热分布测试系统对同样漏电芯片表面温度进行测量,发现芯片正负电极温度差距很大,数据显示如图,负极电极温度为129.2℃,正极电极温度为82.0℃,电极两端温差>30℃。

死灯芯片正极金道FIB切割:
金鉴工程师对死灯灯珠芯片正极金道做FIB切割,结果显示芯片采用Cr-Al-Cr-Pt-Au反射结构,金鉴发现:
1.Cr-Al-Cr-Pt层呈现波浪形貌,尤其ITO层呈现波浪形貌,ITO层熔点较低,正极在高温下,芯片正极ITO-Cr-Al-Cr-Pt层很容易融化脱落,这也是金鉴观察到前面部分芯片正极脱落的原因。
2.芯片正极的铝层厚度约为251nm,明显比负极100nm要厚,而负极和正极Cr-Al-Cr-Pt-Au是同时的蒸镀溅射工艺,厚度应该一致。
3.在芯片正极金道ITO层下,我们没有发现二氧化硅阻挡层。而没有阻挡层恰好导致了正负电极分布电流不均,电极温差大,造成本案的失效真因。
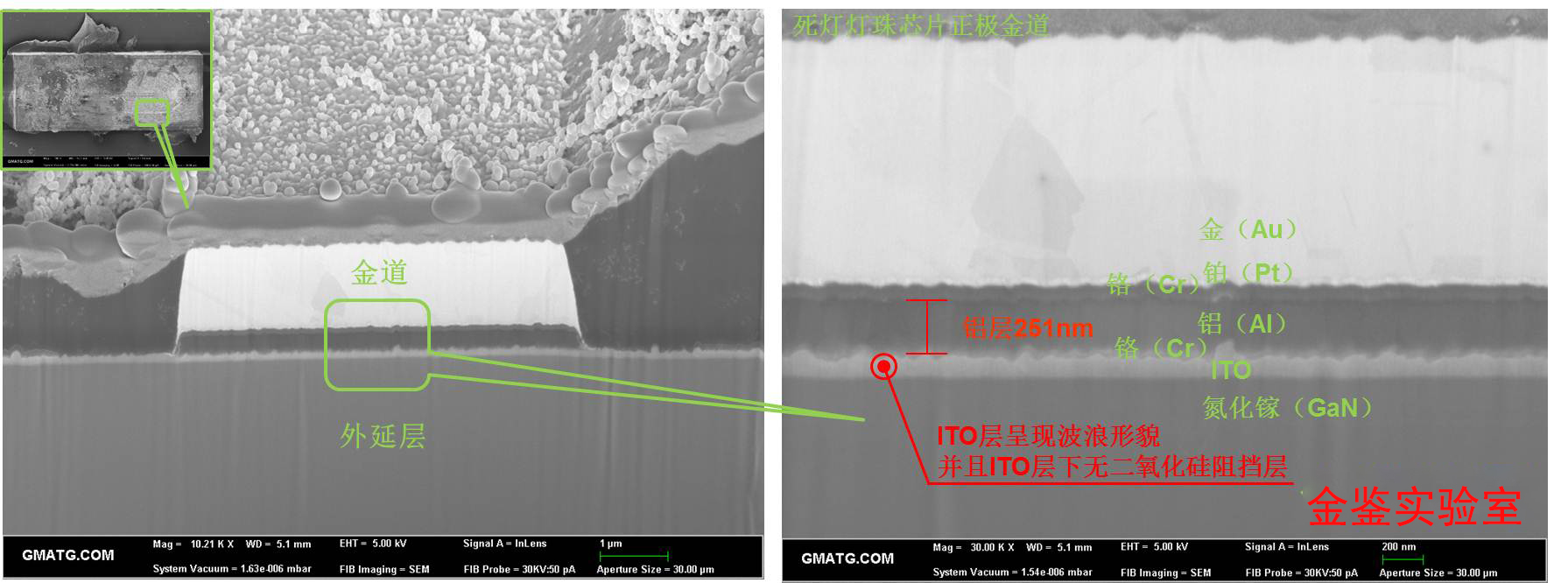
案例四:委托单位送测LED灯珠样品,要求使用显微热分布测试系统观察灯珠在不同电流下表面温度的变化情况。
对大尺寸的倒装芯片进行观察:
开始时样品电流为1A,此时芯片表面温度约134℃;一段时间后,电流降低到800mA,温度在切换电流后的2s内,温度下降到125℃,随后逐渐下降到115℃达到稳定;紧接着再把电流降低到500mA,10s后,温度从115℃下降到91℃。
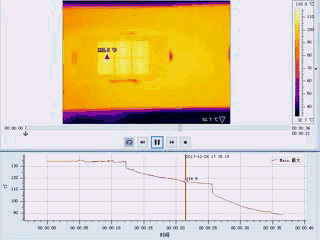
对小尺寸的倒装芯片进行观察:
样品在300mA下稳定时,芯片表面温度约为68℃;电流增加到500mA,10s后温度上升到99℃;随后把电流降低到200mA,13s后温度下降到57℃,此时把电流增加到400mA,芯片表面温度逐渐上升,在20s后温度达到稳定,此时温度约为83℃;最后把电流降低到100mA后,温度逐渐下降。
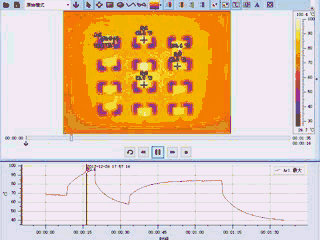
案例五:电源失效分析之热点定位
委托单位电源出现失效现象,委托金鉴查找电源失效原因。在该案例中,金鉴使用显微红外热点定位测试系统对电源进行测试,定位到电源结构中的R5电阻在使用时发热严重,经测温发现该电阻温度高达90℃。厂家建议碳膜电阻在满载功率时最佳工作温度在70℃以下,而该电源中R5碳膜电阻在90℃温度下满载工作,长期使用过程中导致R5电阻失效。
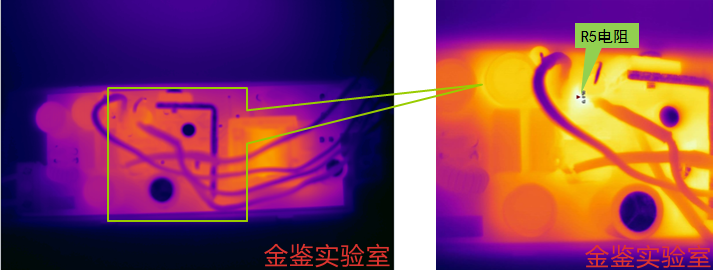
案例六:
测试原理:PCB器件存在缺陷异常或性能不佳的情况下,通常会表现出异常局部功耗分布,最终会导致局部温度升高。金鉴显微红外热点定位系统利用新型高分辨率微观缺陷定位技术进行热点锁定(lock in) ,可快速而准确地探测细微缺陷(异常点)位置。
室温24.5℃条件下,对待测区域施加5V电压,此时导通电流为20mA。使用显微热点定位系统测试PCB板热点。如红外热点定位图所示,其中红色三角形标识处即为热点所在,红外-可见光融合图可观察到热点在PCB板上的位置,该热点位置即为PCB板漏电缺陷位置。
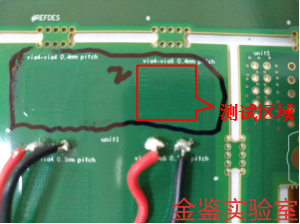
局部漏电PCB样品
红外热点定位测试

红外热点定位图 可见光图(测试区域) 红外-可见光融合图
通过金鉴实验室的专业测试,客户能够在复杂的电子产品研发和质量控制中,获得更高的效率和可靠性,推动企业的持续发展与创新。
- 上一篇: 导热系数测试仪
- 下一篇: 热机械分析仪(TMA)






