热阻热瞬态测试仪(T3ster) 发布时间:2024-11-13 10:20:06
一.T3ster及其特点
热瞬态测试仪T3Ster,用于半导体器件的先进热特性测试仪,同时用于测试IC、SoC、SIP、散热器、热管等的热特性。
1.兼具 JESD51-1定义的静态测试法(Static Mode)与动态测试法(Dynamic Mode), 能够实时采集器件瞬态温度响应曲线 (包括升温曲线与降温曲线),其采样率高达 1 微秒,测试延迟时间高达 1 微秒,结温分辨率高达 0.01℃。
2.既能测试稳态热阻,也能测试瞬态热阻抗。
3.满足JEDEC最新的结壳热阻(θjc)测试标准(JESD51-14)。
4.测试方法符合 IEC 60747系列标准。
5.满足 LED 的国际标准 JESD51-51,以及LED 光热一体化的测试标准 JESD51-52。
6.测试方法符合 MIL-STD-883H method 1012.1 和 MIL-750E 3100 系列的要求。
7.结构函数分析法,能够分析器件热传导路径上每层结构的热学性能(热阻和热容参数),构建器件等效热学模型。
8.可以和热仿真软件 Flotherm,FloEFD 无缝结合,将实际测试得到的器件热学参数导入仿真软件进行后续仿真优化。

测试LED产品的相关参数:
基板温度:室温~90℃
最小采样时间间隔:1μs
结温测试分辨率:0.01℃
典型电压测量分辨率:12μV
二. T3Ster 系统技术规格
1.加热功率:0-38A/40V(电流线性可调),满足大功率高压LED产品测试;
2.电流范围:0-38A,线性输出;
3.器件电压:0-40V;
4.电流准确度:0.05%;
5.K系数测试电流:0-200mA(电流线性可调),与外部控温装置联动,自动测试K系数;
6.电流范围:0-200mA,线性输出;
7.Gate控制电压:0-10V(线性可调);
8.加热状态到测试状态切换时间:1s;
9.具有循环脉冲输出功能:输出脉冲循环次数可设置一次到无数次;
10.温度测试方法:ETM测试法(器件导通电压作为温度敏感变量),兼容三大测试标准:JEDEC(JESD51-1,JESD51-14,JESD51-50,JESD51-51,JESD51-52),MIL-STD-750E,IEC60747;
11.瞬态热测试方法:提供两种测试方法:静态测试法(持续加热,热平衡后,冷却中连续测试);动态测试法(脉冲加热,单点测试);
12.电压信号采样速率:1us/次;
13.温度采样精度:0.0006℃(电压分辨率12uV模式下);
14.瞬态热测试完成后,输出的热阻热容网络模型,可以被热仿真软件使用,进行仿真分析;
15.通过分析软件可得到内部机构函数,结构函数反映了从发热源(原点)到环境(最后直线向上部分)的热流路径上的所有热容与热阻分布。根据结构函数上斜率(热容与热阻的比值)变化,可以区分出不同材料,用直观的方式,帮助分析散热路径上不同材料的热阻与热容;
16.光、热、电联合测试,可配合积分球和光学测试主机进行光、热、电联合测试;
17.热电偶测量准确度:+/-0.5℃;
18.热温测量范围:﹣50℃~200℃;
19.热阻可测量范围:0℃/W~1000℃/W;
20.温控装置温控范围:0℃~150℃,温度稳定性﹢/﹣0.2℃。
三. T3Ster 的应用范围及功能
1.应用范围:
①各种三极管、二极管等半导体分立器件,包括:常见的半导体闸流管、双极型晶体管、以及大功率 IGBT、MOSFET、LED 等器件;
②各种复杂的 IC以及 MCM、SIP、SoC 等新型结构 ;
③各种复杂的散热模组的热特性测试,如热管、风扇等 。
2.功能:
①半导体器件结温测量;
②半导体器件稳态热阻及瞬态热阻抗测量;
③半导体器件热阻和热容测量,给出器件的热阻热容结构(RC 网络结构);
④半导体器件封装内部结构分析,包括器件封装内部每层结构(芯片+焊接层+热沉等)的热阻和热容参数;
⑤半导体器件老化试验分析和封装缺陷诊断,帮助用户准确定位封装内部的缺陷结构;
⑥材料热特性测量(导热系数和比热容);
⑦接触热阻测量,包括导热胶、新型热接触材料的导热性能测试。
四. 测试方法——基于电学法的热瞬态测试技术
1.测试方法——电学法
寻找器件内部具有温度敏感特性的电学参数,通过测量该温度敏感参数(TSP)的变化 来得到结温的变化。
TSP 的选择:一般选取器件内 PN 结的正向结电压。
2.测试技术:热瞬态测试
① 当器件的功率发生变化时,器件的结温会从一个热稳定状态变到另一个稳定状态,T3Ster 将会记录结温瞬态变化过程(包括升温过程与降温过程)。
② 一次测试,既可以得到稳态的结温热阻数据,也可以得到结温随着时间的瞬态变化曲线。
③ 瞬态温度响应曲线包含了热流传导路径中每层结构的详细热学信息(热阻和热容参数)。
五.应用实例
1.如何利用结构函数识别器件的结构:
LED的一般散热路径为:芯片-固晶层-支架或基板-焊锡膏-辅助测试基板-导热连接材料
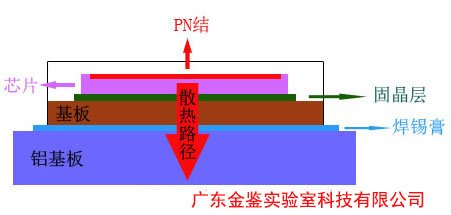
金鉴实验室可以测试LED、BJT、IGBT、HEMT、MOSFET等半导体器件,可以得出如下述的热阻曲线图,可读出测试产品总热阻(整个散热路径),也可根据测试样品的结构,判定曲线中的热阻分层,获得封装器件芯片-固晶层-支架或基板-焊锡膏-辅助测试基板-导热连接材料的热阻。
1)LED热阻曲线(IF=150mA,Tc=25℃)
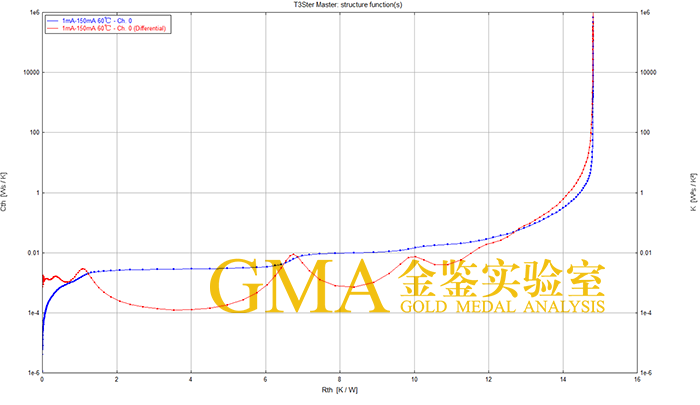
2)BJT热阻曲线图(IF=500mA,Tc=25℃)
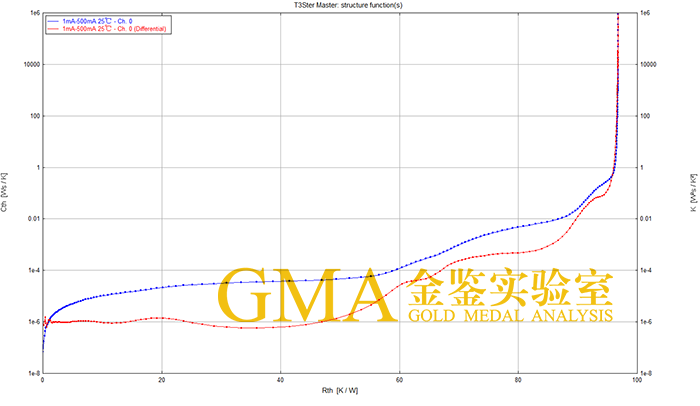
3)IGBT热阻曲线图(IF=800mA,Tc=25℃)
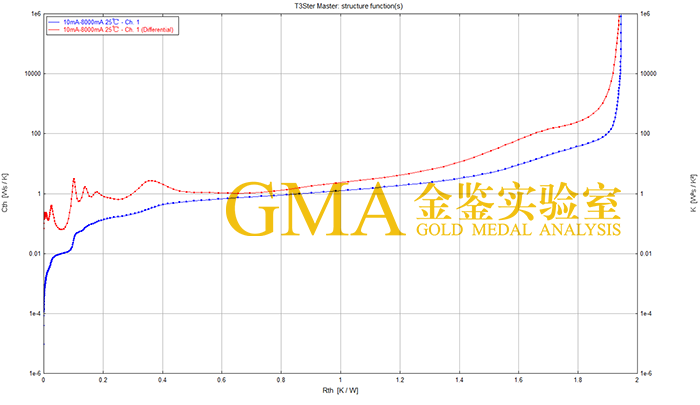
4)HEMT热阻曲线图(IF=10000mA,Tc=25℃)
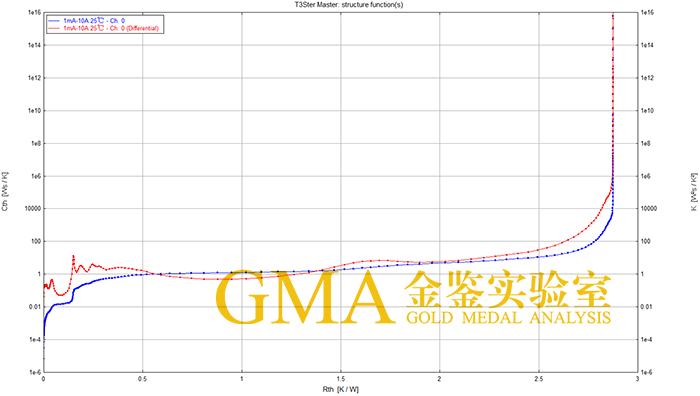
5)MOSFET热阻曲线图(IF=3000mA,Tc=25℃)

如下面结构函数显示,结构函数上越靠近 y 轴的地方代表着实际热流传导路径上接近芯片有源区的结构,而越远离 y 轴的地方代表着热流传导路径上离有源区较远的结构。
积分结构函数是热容—热阻函数,曲线上平坦的区域代表器件内部热阻大、热容小的结构,陡峭的区域代表器件内部热阻小、热容大的结构。
微分结构函数中,波峰与波谷的拐点就是两种结构的分界处,便于识别器件内部的各层结构。
在结构函数的末端,其值趋向于一条垂直的渐近线,此时代表热流传导到了空气层,由于空气的体积无穷大,因此热容也就无穷大。从原点到这条渐近线之间的 x 值就是结区到空气环境的热阻,也就是稳态情况下的热阻。
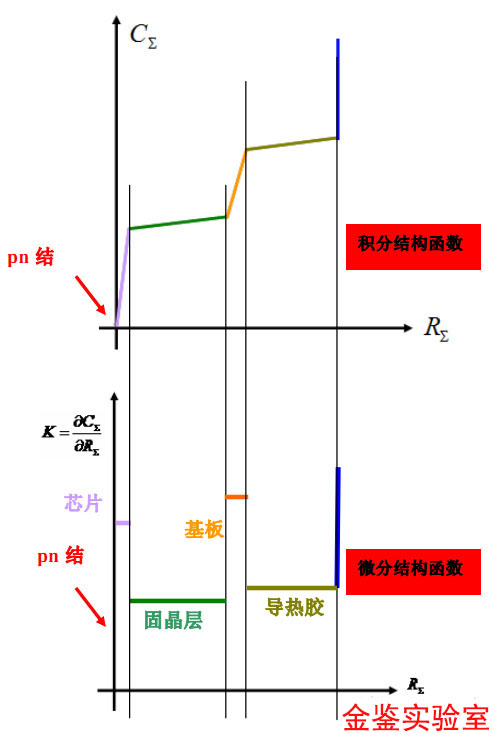
2.利用结构函数识别器件封装内部的“缺陷”:
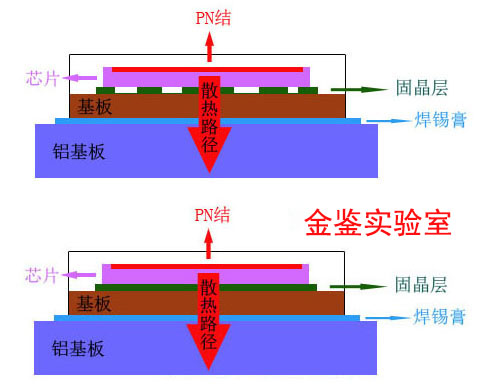
对比上面两个器件的剖面结构,固晶层可见明显差异。如下图,左边为正常产品,右边为固晶层有缺陷的产品。
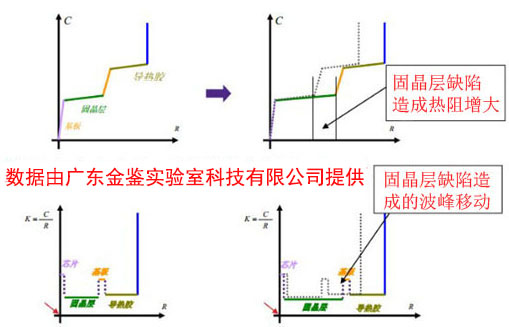
根据上图显示,固晶层缺陷会造成的热阻增大,影响散热性能,具体的影响程度与缺陷的大小有关。
3.测量结壳热阻:
两次测试的分别:第一次测量,器件直接接触到基板热沉上;第二次测量,器件和基板热沉中间夹着导热双面胶。由于两次散热路径的改变仅仅发生在器件封装壳之外,因此结构函数上两次测量的分界处就代表了器件的壳。如下图所示的曲线变化,可得出器件的精确热阻。
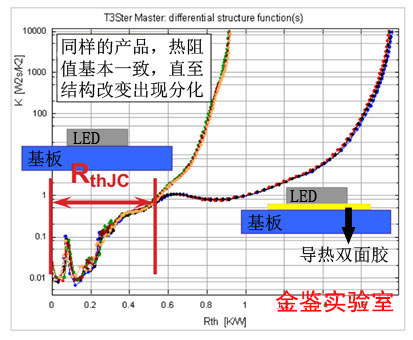
4.结构无损检测:
同批次产品,取固晶层完好、边缘缺陷以及中间缺陷的样品测试。固晶完好的固晶层应为矩形,而边缘和中间存在缺陷,则固晶层不规则,下图两种缺陷的图片。
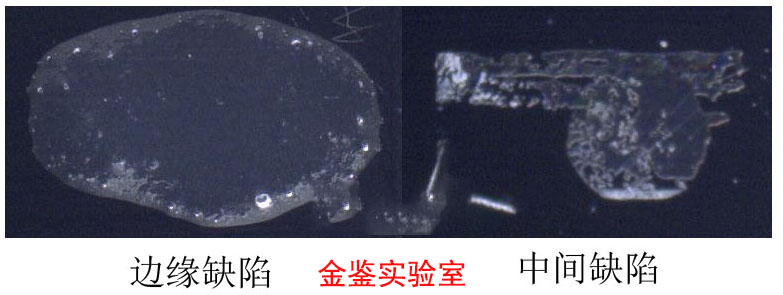
测试出三条热阻曲线。由于三次测试的芯片是一样的,因此在结构函数中表征芯片部分的曲线是完全重合在一起的。随着固晶层损伤程度的增加,该结构层的热阻逐渐变大。这是由于空洞阻塞了有效的散热通道造成的。

根据测试结果,不仅可以定性地找出存在缺陷的结构,而且还能定量得到缺陷引起的热阻的变化量。
5.老化试验表征手段:
下图为一个高温高湿老化案例中同一样品不同时期的热阻曲线。

老化前后,从芯片后波峰的移动可以清晰地看出由于老化造成的分层,导致了芯片粘结层的热阻增大。对样品不同阶段的热阻测试,可得到每层结构的热阻变化,根据变化分析老化机理,从而改善产品散热性能。
- 上一篇: 导热系数测试仪
- 下一篇: 热机械分析仪(TMA)






