聚焦离子双束显微镜(FIB-SEM) 发布时间:2024-06-03 16:41:24
一、设备型号
三台FIB-SEM,分别是Zeiss Auriga Compact FIB-SEM、FEI Helios Nanolab 450S、FEI Scios2。
先进的X-Max大面积晶体电制冷能谱探头,提供轻元素分辨率, 并给出测试条件≤127eV (Mn Ka 20,000cps) 元素范围:Be4-Pu94 Si晶体, 20mm2活区。
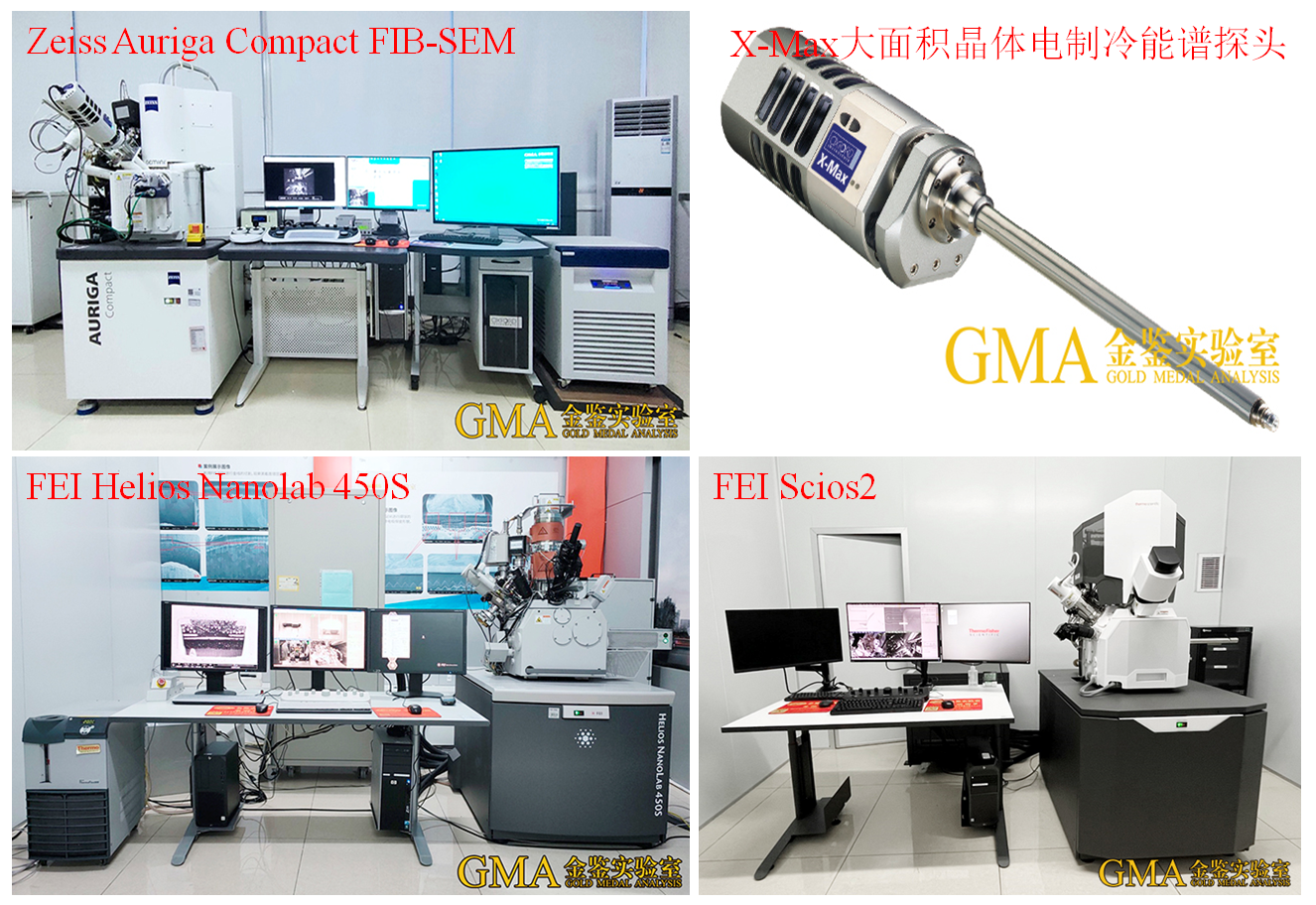
二、原理
聚焦离子束(Focused Ion Beam,FIB)与扫描电子显微镜(Scanning Electron Microscope,SEM)耦合成为FIB-SEM双束系统后,通过结合相应的气体沉积装置,纳米操纵仪,各种探测器及可控的样品台等附件成为一个集微区成像、加工、分析、操纵于一体的分析仪器。其应用范围也已经从半导体行业拓展至材料科学、生命科学和地质学等众多领域。
三、技术参数
金鉴实验室蔡司Zeiss Auriga Compact FIB-SEM技术参数:
AURIGA Compact 主机台 | FESEM | FIB |
分辨率 |
0.9nm at 30kV 1.2nm at 15kV and optimum WD 2.5nm at 1kV and optimum WD
| 5nm(30kV,1pA) |
放大倍率 | 12x-1000kx | 600x-500kx |
束流 | 4pA-100nA | 1pA-20nA |
加速电压 | 0.1-30kV | 1-30kV |
电子枪 | 肖特基热场发射型 | Ga液态金属离子源(LMIS) |
金鉴实验室FEI Helios Nanolab 450S 特点:
用FIB切割样品,然后用SEM对缺陷进行定位和成像。
使用FIB可以切一样品薄片厚度(30-50nm),取出以后,然后用带有EDS/EELS探测器的TEM/STEM对其成像同时测量其化学性质。
Helios NanoLab 450S是高通量、高分辨率TEM制样、成像和分析的理想选择。
其独有的可翻转样品台和原位STEM探测器可以在几秒钟内从制样模式翻转到样品成像模式,且无需破真空或将样品暴露在环境中。
金鉴实验室FEI Helios Nanolab 450S FIB-SEM技术参数:

金鉴实验室FEI Scios2特点:
超高分辨率聚焦离子束扫描电子显微镜,可进行高质量样品制备和3D表征。通过将Scios 2 DualBeam的最新技术创新与可选配的、易使用的、全面的 Thermo Scientific AutoTEM 4软件以及赛默飞世尔科技的应用专业知识相结合,可快速方便地制备用于多种材料的现场指定高分辨率 S/TEM样品。
金鉴实验室FEI Scios2 FIB-SEM技术参数:
电子束分辨率,最佳工作距离
• 在 30 keV (STEM) 下,为 0.7 nm
• 在 1 keV 下,为 1.4 nm
• 1 keV 时为 1.2 nm,配备电子束减速*
电子束参数空间
• 电子束电流范围 :1 pA - 400 nA
• 实际着陆能量范围 :20* eV - 30 keV
• 加速电压范围 :200 V - 30 kV
灵活的5轴电动载物台
• XY 范围 :110 mm
• Z 范围 :65 mm
• 旋转 :360˚(无穷)
• 倾斜范围 :-15˚ 至 +90˚
• XY 重复性 :3 μm
四、聚焦离子束技术(FIB)注意事项:
(1)样品大小5×5×1cm,当样品过大需切割取样;
(2)样品需导电,不导电样品必须能喷金增加导电性;
(3)切割深度必须小于10微米。
五、金鉴实验室FIB-SEM技术及应用:
为方便客户对材料进行深入的失效分析及研究,金鉴实验室现推出Dual Beam FIB-SEM业务,并介绍Dual Beam FIB-SEM在材料科学领域的一些典型应用,包括透射电镜( TEM)样品制备,材料微观截面截取与观察、样品微观刻蚀与沉积以及材料三维成像及分析等。
1.一般的tem制样就成主要包括
1.1 粗挖
利用较束流(一般选用30na)挖到目标区域两侧
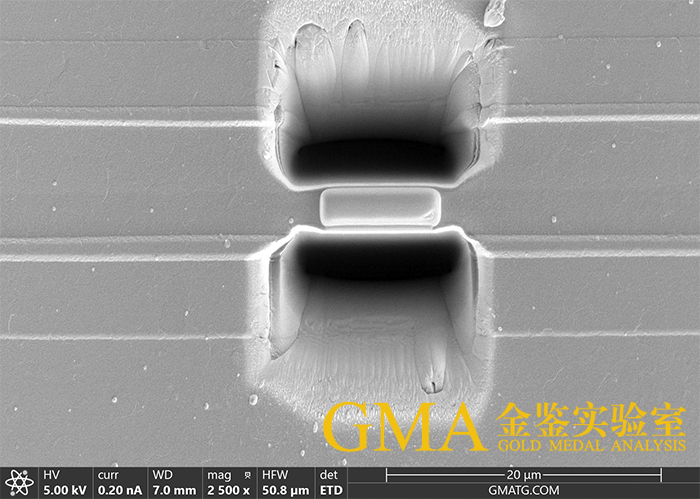
1.2 细挖
利用较小束流(一般选用3na)把薄片修至1-1.5nm
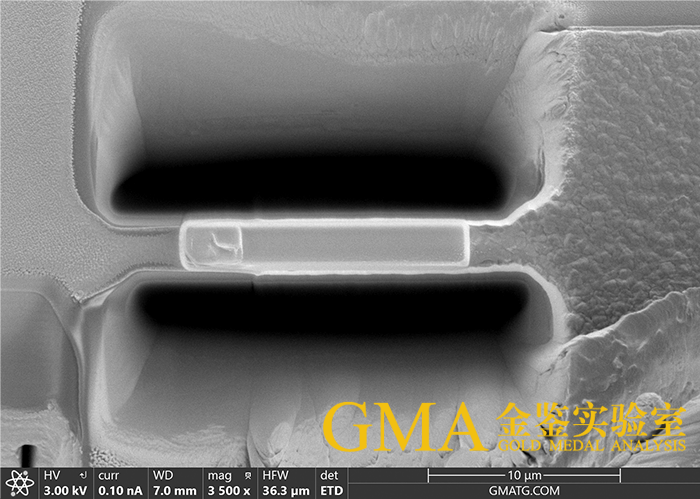
1.3 U-CUT
0°在I-beam上把样品的底部和侧面剪断
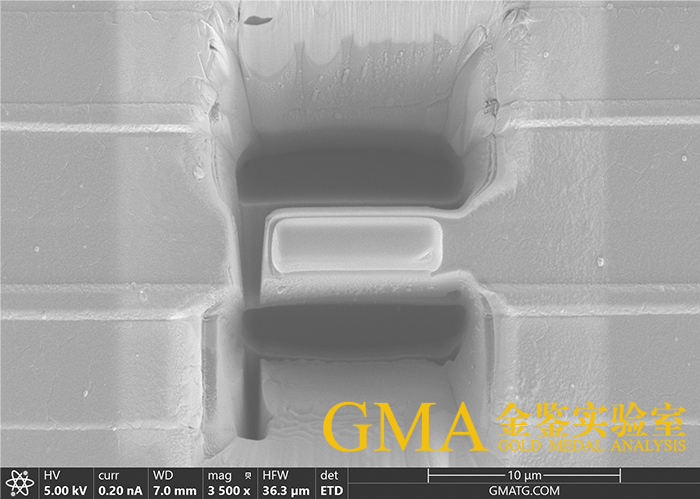
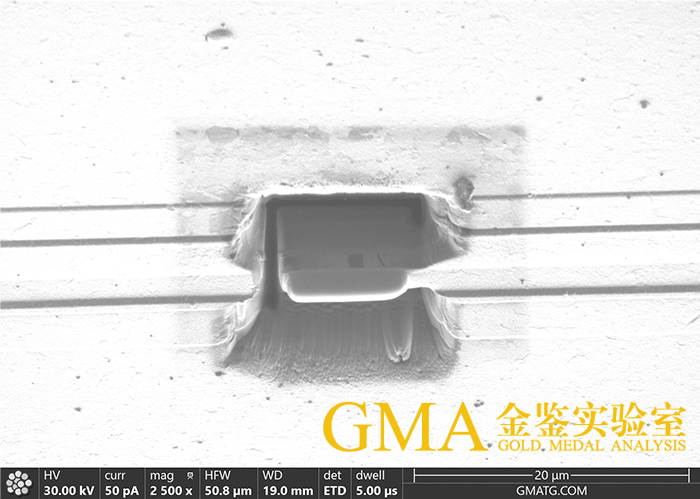
1.4 提样
使用纳米手将薄片提出并焊接到Grid上
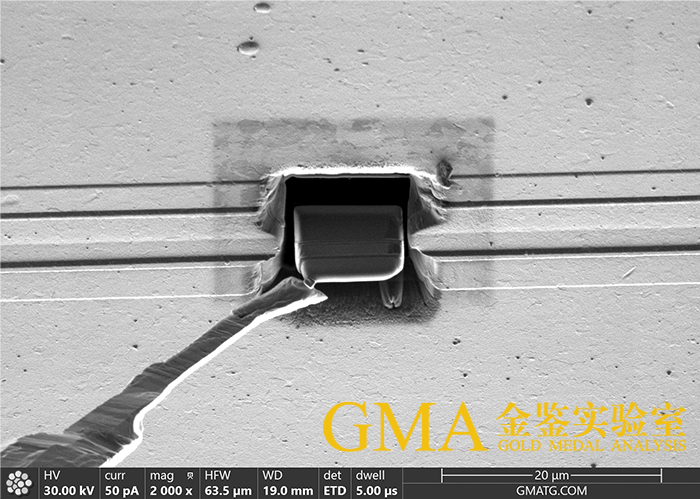
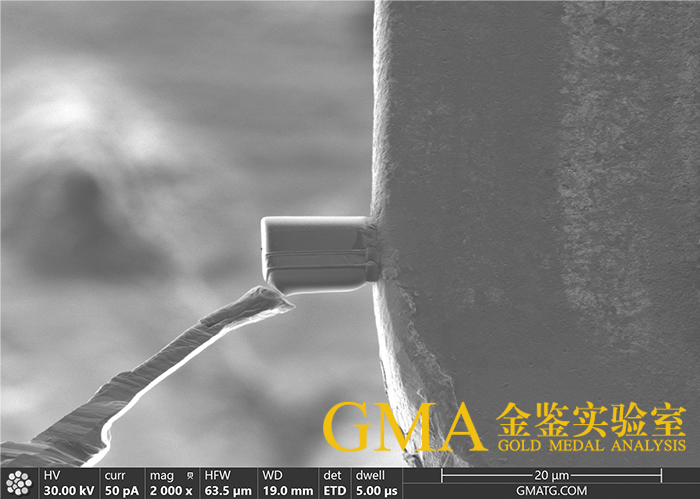
1.5 剪薄
使用30Kv 0.5na-10pa之间的小束流两侧均匀剪薄
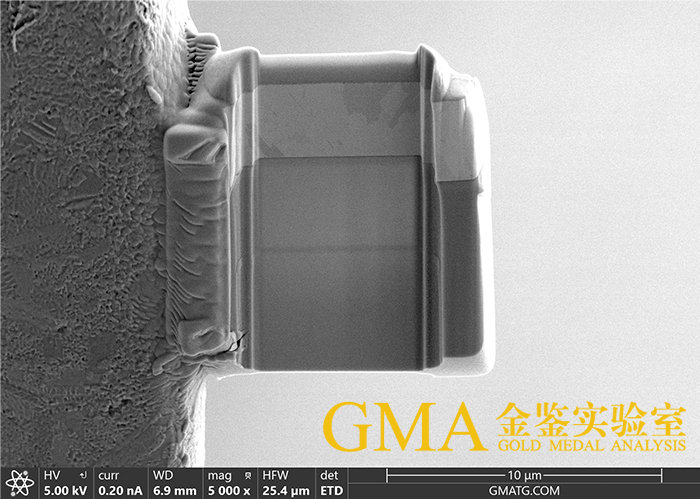
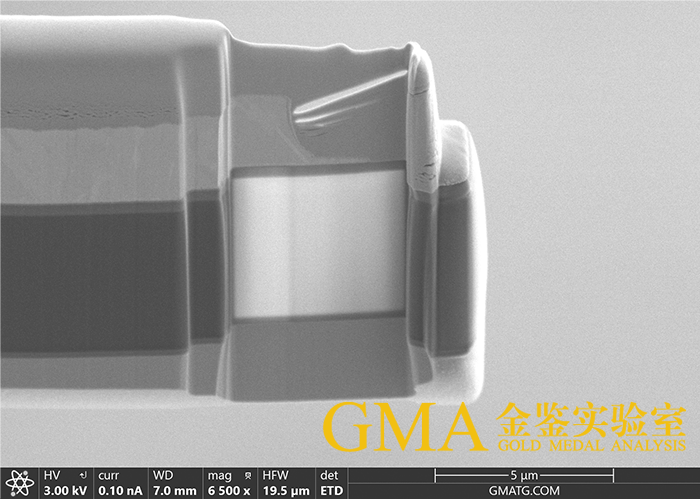
1.6 清洗
对样品进行不定型层的清洗,清除不定型层
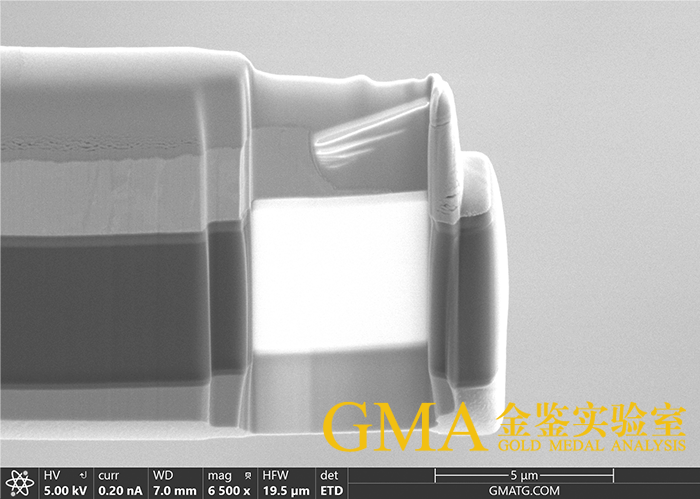
2.材料微观截面截取与观察
SEM仅能观察材料表面信息,聚焦离子束的加入可以对材料纵向加工观察材料内部形貌,通过对膜层内部厚度监控以及对缺陷失效分析改善产品工艺,从根部解决产品失效问题。
(1)FIB切割键合线
利用FIB对键合线进行截面制样,不仅可以观察到截面晶格形貌,还可掌控镀层结构与厚度。
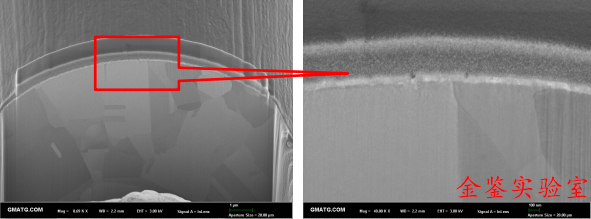
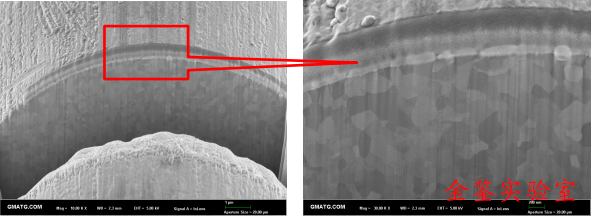
(2)FIB切割芯片金道
金鉴实验室FIB-SEM产品工艺异常或调整后通过FIB获取膜层剖面对各膜层检查以及厚度的测量检测工艺稳定性。
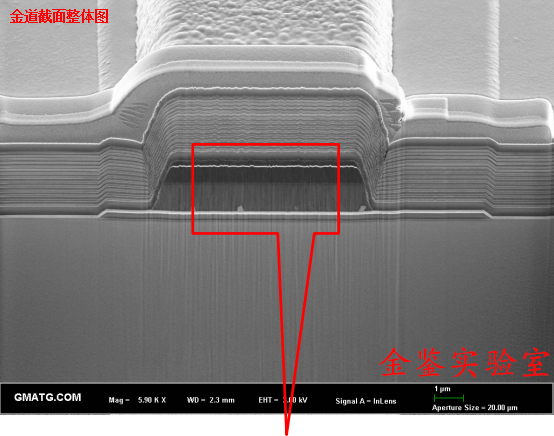
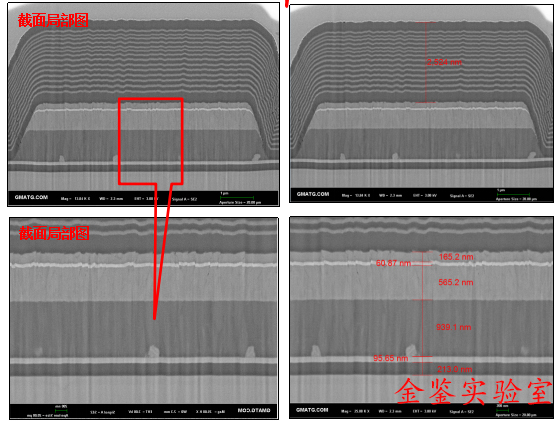
(3)FIB切割支架镀层
利用FIB切割支架镀层,避免了传统切片模式导致的金属延展、碎屑填充、厚度偏差大的弊端,高分辨率的电镜下,镀层晶格形貌、内部缺陷一览无遗。
FIB-SEM扫描电镜下观察支架镀层截面形貌,镀层界限明显、结构及晶格形貌清晰,尺寸测量准确。此款支架在常规镀镍层上方镀铜,普通制样方法极其容易忽略此层结构,轻则造成判断失误,重则造成责任纠纷,经济损失!
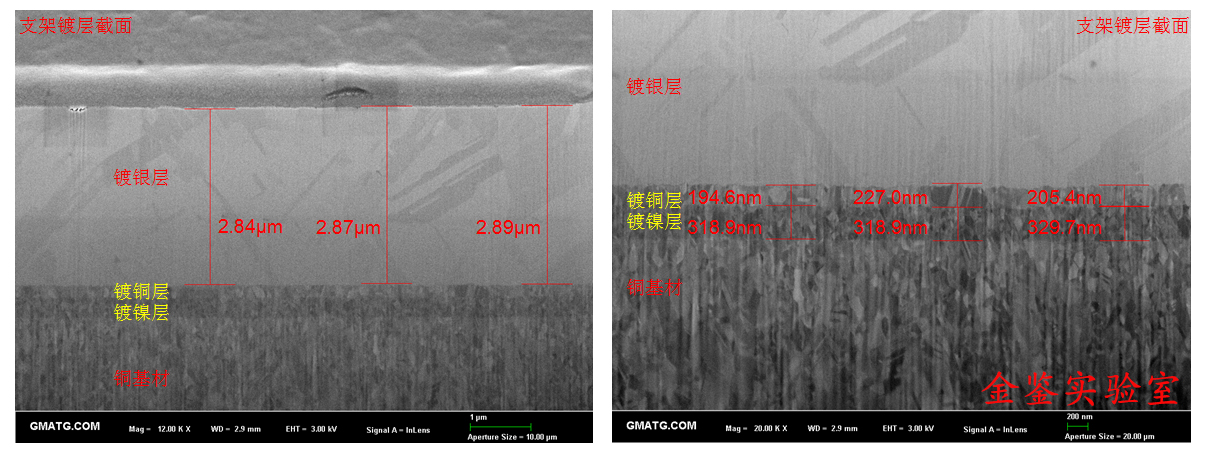
FIB-SEM扫描电镜下观察支架镀层截面形貌。此款支架在镀铜层下方镀有约30纳米的镍层,在FIB-SEM下依然清晰可测!内部结构、基材或镀层的晶格、镀层缺陷清晰明了,给客户和供应商解决争论焦点,减少复测次数与支出。
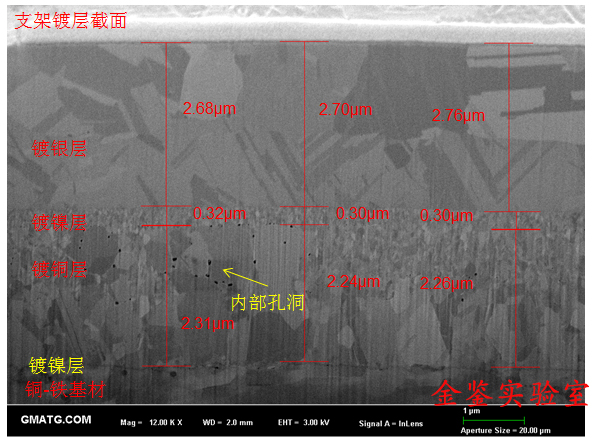
(4)FIB其他领域定点、图形化切割
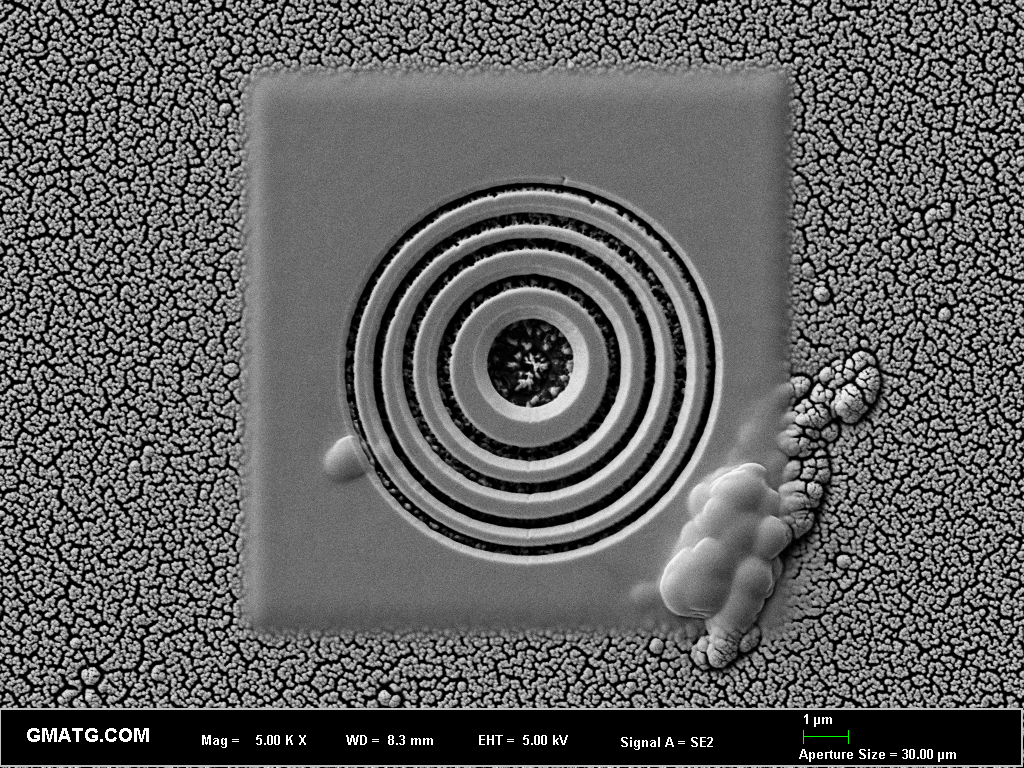
3. 诱导沉积材料
利用电子束或离子束将金属有机气体化合物分解,从而可在样品的特定区域进行材料沉积。本系统沉积的材料为Pt,沉积的图形有点阵,直线等,利用系统沉积金属材料的功能,可对器件电路进行相应的修改,更改电路功能。

- 上一篇: 透射电镜(TEM)
- 下一篇: 电子背散射衍射(EBSD)






