激光开封系统(粗开封) 发布时间:2025-06-24 14:05:57
一、设备型号
GMATG-T1

金鉴激光开封系统(粗开封)
金鉴GMATG-T1是金鉴实验室推出的激光开封系统,针对半导体失效分析实验室应用场景设计,根据不同材料对激光吸收特性的不同,选择性刻蚀。金鉴采用定制的激光器、控制器,可适用高达99%的封装材料,光斑质量好,寿命长,保证最佳匹配无损晶圆及线材的激光开封。开封参数可精确控制,确保线材无损、开封的后IC可以保留焊盘,将芯片及压焊打线的情况清晰展现。同时取代机械开封、化学开封、传统制模、机械切割研磨等制样工艺,大大降低开封成本,节省开封时间,提高开封良率。
金鉴激光开封系统主要构成:激光器、光路系统、工作台、控制系统等。采用自研发的控制软件、直接导入CAD数据进行激光刻蚀,操作简单。设备集数控技术、激光技术、软件技术等光机电高技术于一体,具有高灵活性、高精度、高速度等先进制样技术的特征。适用于各种塑料封装形式的IC开封,LED透明硅胶和环氧树脂,为各种类型的半导体失效分析应用(如半导体器件开盖和剖面)提供清晰,精确的测试样品。
GMATG金鉴激光开封机 | FALIT激光开封机 | |
生产厂家 | 金鉴实验室 | 控制激光公司(CLC) |
产地 | 中国 | 美国 |
设备售价 | 大大降低 | 100万 |
设备构成 | 设备集数控技术、激光技术、软件技术等光机电高技术于一体,具有高灵活性、高精度、高速度等先进制样技术的特征。 | 定位系统、抽尘系统、风冷系统需选配、无水冷系统。 |
工作原理 | 根据不同颜色的材料对激光的吸收特性的不同,选择性的刻蚀。例如:玻璃为透红外光材料,透射率几乎为1,对红外光不吸收,导致红外光无法刻蚀琉璃材料。金属为不透光材料,但是对光的反射率高,透射率为零,反射率高,红外能量吸收率低,刻蚀需要的激光功率高。黑胶为不透光材料,透射率为零,反射率低,对能量的吸收率高,刻蚀开封速率快,需要激光功率低。封装胶和环氧树脂胶等具有一定的透射率,相比黑胶对红外光的吸收率低,导致该类胶需要的激光能量高。 | 通过高功率密度激光束照射封装材料,使材料被加热至汽化温度而蒸发,完成开封过程。 |
开封范围 | 金鉴实验室专门为半导体功率器件开封定制的激光器,可开封高达99%的封装材料,包括黑胶、环氧树脂胶、硅胶等,以及含有大颗粒填充物的封装层,还可用于切割样品。 | 标配30瓦红外波长开封定制激光器,只能去除不含有大颗粒填充物的环氧树脂封装层,如需去除大颗粒填充物要选配价格更高的50瓦增强型激光器。 |
功率 | 30W | 标配30W |
波长 | 1064 nm | 1μm |
开封时间 | 很快,数10秒。 | 很快,数10秒。 |
最大开封尺寸 | 150mm*150mm | 38mm*38mm |
软件 | GM-LASER,金鉴实验室激光开封专用软件。 | FALIT Pro-专业版 |
外型尺寸 | 0.26*0.7*0.55m | 1.22x0.76x0.91m |
机身重量 | 30KG | 428.6KG |
使用便利性 | 便携性强,一体化系统。 | 体积重量大,不容易搬动。 |
化学开封 VS 金鉴激光系统开封:
传统的化学开封前期准备工具繁琐、耗时不省心,大多开封化学试剂具有毒性、腐蚀性和挥发性,会刺激呼吸道,长期接触容易诱发呼吸道疾病和皮炎,如果沾染皮肤会造成烧伤,严重者内脏器官受到伤害甚至休克,也有可能会影响到生育。
由于化学开封对人体危害较大,对于现代的很多员工来说,考虑到自身健康,不愿从事化学开放的工作,而金鉴激光开封安全无毒,环境友好,采用激光开封利于增加团队的稳定性。而激光开封相比化学开封可以做到更加精密,线宽更窄,线间距更小,操作简便,随时都可以导入图形或直接绘制图形加工,不受限制,特别适合于实验室阶段。从稳定性、良品率、耗材、环保、综合成本等多种因素考虑,激光开封的优势也更加明显。为此,金鉴镭射定位激光开封系统,帮助客户解决塑封器件开封的烦恼。
塑封器件开封方法比较 | ||||||
传统开封方法 | 开封方法 | 工艺概述 | 开封效果 | 开封时间 | 开封效果 | 对人体的危害 |
化学开封 | 用发烟硝酸和浓硫酸负压喷射腐蚀,用丙酮或乙醇清洗。 | 定位较好,可保持框架,但是对于小型、异形及有多块芯片的器件、难以准确定位开封。无法开封内部有铜、铝等不耐腐蚀材料的塑封器件。 | 慢,几小时 | 较理想 | 刺激呼吸道,长期接触容易诱发呼吸道疾病和皮炎,如果沾染皮肤会造成烧伤,严重者内脏器官受到伤害甚至休克,也有可能会影响到生育。 | |
金鉴开封技术 | 激光开封 | 通过可变功率高密度激光束照射封装材料,使光束聚焦处极小区域内的材料被高温分解或气化后随循环气流带走。以激光束在指定区域内高速移动的方式。逐步完成开封过程。 | 定位精准、方向性好,非接触、无污染,可保留芯片和线材完好无损。可开封内部有不耐腐蚀材料的塑封器件。 | 很快,几十秒开封一个器件。 | 理想 | 激光开封,安全无毒。 |
二、功能介绍:
1. 金鉴GMATG自开发的软件,微米级精准逐层开封!
(1)金鉴激光定位系统,精准定位开封位置。
(2)可精确控制每一层激光扫描能量,每层移除厚度可控制在10~100 μm,精准定位开封区域,暴露引线框架,邦定线,基板,甚至直接无损开封至芯片的晶圆层。
(3)显著节省后续工艺时间。
(4)电脑控制开封形状、位置、大小、时间等,操作便利。
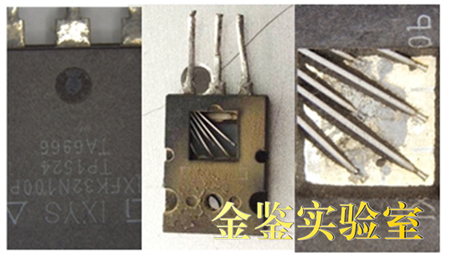
金鉴工程师对MOS芯片样品逐层开封
2. 功率可调,最大程度上减少激光对金属材料的热影响
(1)可开封高达99%的封装材料,环氧树脂,硅胶等。
(2)可适合各种硅胶、塑料封装形式的IC开封,包括DIP、SOP、PDIP,PLCC,PQFP,SOIC,BGA以及COB去黑胶等。
(3)适用多芯片、多细线材塑封器件样开封!
传统化学开封方式对多芯片样品束手无策,原因在于长时间的化学开封溶解胶体的同时,也会溶解芯片固晶层和焊线金属,降低焊点结合力,导致在超声波清洗后,焊线断裂,芯片脱离,失去样品原始原貌,无法分析。
同样道理,对于细线塑封器件,化学开封极易损伤焊线金属,而传统的激光开封由于热影响,较细的焊线很容易受到热损伤,在超声波清洗之后,发生焊线断裂的现象。
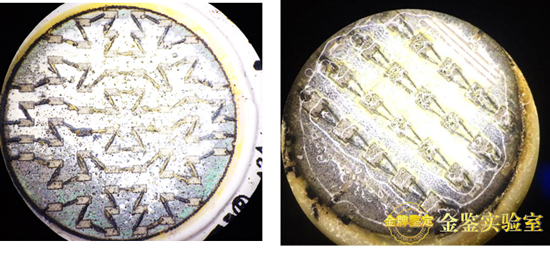
激光开封后的COB LED光源,焊线和芯片无损
(4)铜线产品的有效解决方案。由于铜线低廉的价格及性能方面的优势,如今内引线为铜材质的塑封器件已经得到广泛的应用,而铜却容易与酸发生反应而被腐蚀,传统的酸开封已经没有办法完成铜制成器件的开封,良率一般低于30%,金鉴的激光开封机,给分析产业带来了新的技术。
(5)其大功率模式可清洁封装材料中的大颗粒填充料
3. 可导入X-Ray、SEM、C-SAM等图片
(1)由其他失效分析设备生成的图像文件,可直接导入至金鉴实验室GM-LASER激光开封专用分析软件。如: X-Ray、SEM、C-SAM。
(2)导入的文件可在软件中进行缩放融合,调整至实时图像大小,并可设置透明度,以便精准定位开封位置。
(3)将开封几何矢量形状画至图像上,选择区域全部开封,或仅开封缺陷位置或其他感兴趣位置,避开无需开封位置,更易控制无损开封。
4. 开封速度快,开封只需数十秒!
(1)增强型激光控制器结合软件功能,大大优化陶瓷金属封装材料的开封。
(2)激光器:寿命10万小时,扫描振镜,高速精准,先进控制单元使扫描速度快,扫描角度和扫描频率稳定快速可调。
(3)开封的效果与激光器的参数、功率、光路器件、加工速度和材料厚度等条件息息相关的。一般来说,激光器的开封功率越高,开封速度越快。根据金鉴实验室经验,激光开封通常在切割断面有轻微的碳化,而想要完全无碳化则需要降低切割速度来实现。
5.可剖面切割,代替传统的金相制样

应用激光剖面切割工艺,可代替传统的金相磨样工艺
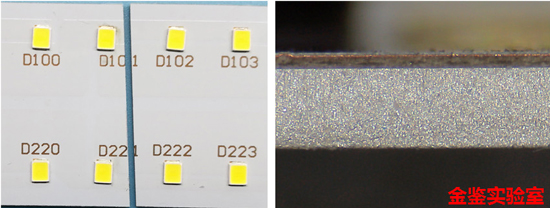
LED灯板激光切割,切割线条平整,截面各层结构界限清晰
(1)GM-LASER 轻松进行PCB板材、金属或陶瓷板材切割。
(2)在这里指出,金鉴实验室GMATG激光切割,并不是像机械切割一样直接穿透切割,是扫描剥离的方式加工的。
(3)传统方式加工PCB,主要包括走刀、铣刀、锣刀等,存在着粉尘、毛刺、应力的缺点,对小型或载有元器件的PCB线路板影响较大,无法满足新的应用需求。而激光技术应用在PCB切割上,为PCB金相制样提供了新的技术方向。激光切割PCB,先进激光加工技术可一次直接成型,非接触加工具有无毛边、精度高、速度快、间隙小、热影响区域小等优点,与传统的切割工艺相比,激光切割完全无粉尘、无应力、无毛刺,切割边缘光滑整齐,特别是加工焊有元器件的PCB板不会对元器件造成损伤。
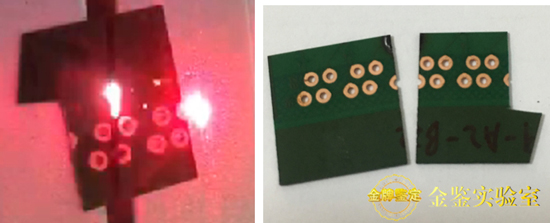
金鉴激光切割PCB板,切口平整
6.可开盖金属/陶瓷封装

局部加热,精确控制加热量,切割并打开LD激光器金属封装盖
三、应用领域:
1. 半导体失效分析
传统的芯片化学开封被定义为有损性工艺,只可复核无损观测到的失效点。应用激光工艺的物理开封也可以是无损工艺。 激光工艺可以无损开封至部分芯片的晶圆层。 选用高光子能量的短波长激光器,激光工艺可完全取代传统的制模倒模、机械切割研磨,部分激光剖面甚至无需后续研磨。 激光切割不仅可以用于芯片剖面,更可用于打开金属或陶瓷封装盖,开盖工艺是传统机械切割难以或无法达成的。
微区线路修改:激光焊接,通过激光的微区加热功能实现线路的修改,实现实验后失效样品的电特性恢复以节省漫长的重新抽样实验,比如实现LED灯珠二焊点的重新焊接。
失效点定位及隔离:通过使不同位置的连接线部分暴露,实现点与点之间的通断性 测试以精确确定失效点。如电性异常电子元器件,选择部分开封,漏出部分键合线后进行测试,定位失效点。
2. 电镜激光制样
可用于扫描电镜SEM、透射电镜TEM前期制样材料切割打磨,代替传统机械切割,离子抛光的方式制作样品,高效快速,质量高。

硅片切割
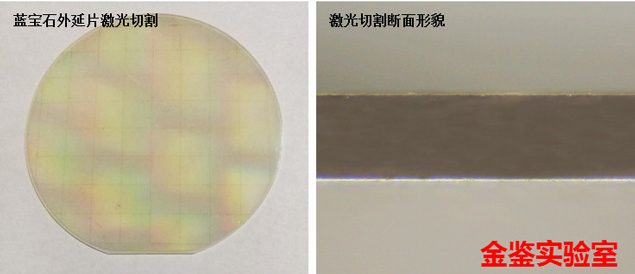
蓝宝石外延片切割
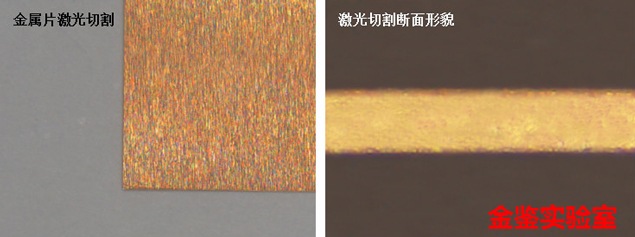
金属切割

陶瓷切割
3. 存储芯片数据恢复
激光无损开封移除芯片塑封层,裸露邦定线和晶圆层,可配合使用探针板读取损毁存储芯片内部分或全部数据。
案例:警察抓捕非法黑客或恐怖分子驻点,电脑在抓捕前被损毁,通过激光开封配合探针板,可读取存储芯片部分或全部数据内容,取得证据将将嫌疑人定罪。
4. 高可靠性芯片防伪验证
汽车、航空、潜艇等应用领域对芯片有高可靠性要求,然而伪造芯片或拆机片渗入分销渠道影响整机安全性。激光开封后,可用显微镜观察验证芯片引线框架上的原厂微型激光防伪码。
案例:某智能汽车发生安全事故,汽车制造商签约的保险公司委托第三方进行失效分析,通过激光开封发现伪造芯片,确定次级分销商事故责任,证实制造商芯片设计无过失。
四、案例实例:
案例一:
委托单位送测MOSFET样品,要求进行激光开帽实验+芯片形貌观察:

客户送测样品及开封效果图
金鉴工程师对芯片进行激光无损开封实验后在光学显微镜下观察芯片形貌。
案例二:
客户的LED直插灯珠出现了死灯问题,反馈LED环氧树脂很难开封,开封了许久也没有达到理想的开封效果,不是胶未融好,就是开封过头,芯片都掉了。

LED直插灯珠
客户要求金鉴工程师对样品开封后进行死灯失效分析。金鉴工程师对客户送测环氧树脂LED直插灯珠进行精准定位切割开封,开封后金包银键合线材、弧度完好,芯片完整无损,器件内部无损!
良品灯珠激光开封后:
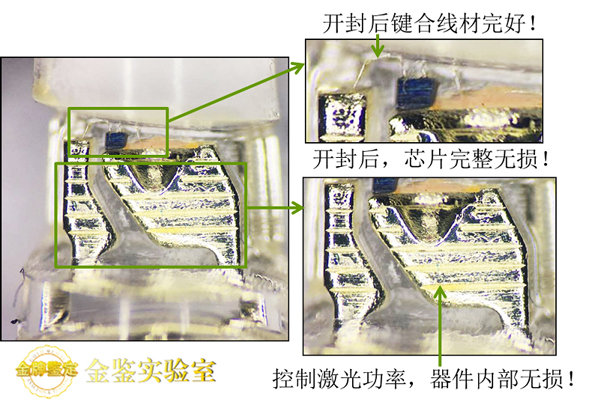
环氧树脂LED直插灯珠开封效果图
失效灯珠激光开封后SEM观察:
SEM下观察灯珠键合线,发现灯珠二焊点E点剥离:
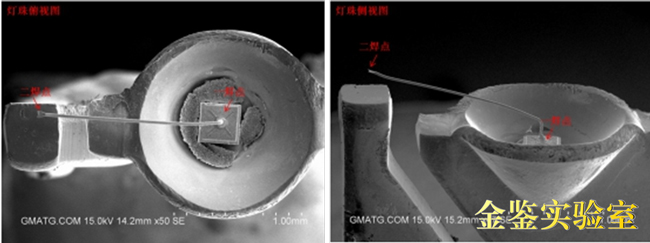
开封后LED直插灯珠SEM观察
案例三:
客户送测不良漏电MOS 芯片,金鉴工程师随机抽取其中一个漏电失效MOSFET器件芯片样品进行激光开盖后,利用显微红外热点定位系统作初步漏电失效分析。
金鉴工程师用激光开封打开漏电失效MOSFET器件芯片环氧树脂封装盖:

利用GMATG-A4可见光-热分布双视分析功能精确定位漏电失效热点:
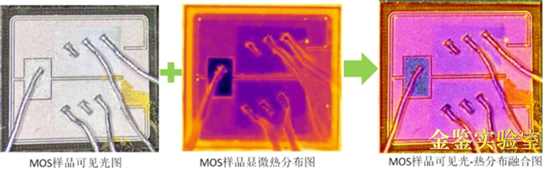
案例四:
客户某批次的COB光源出现大量的发黑死灯异常,送测样品要求观察COB光源内部并分析光源黑化死灯原因。
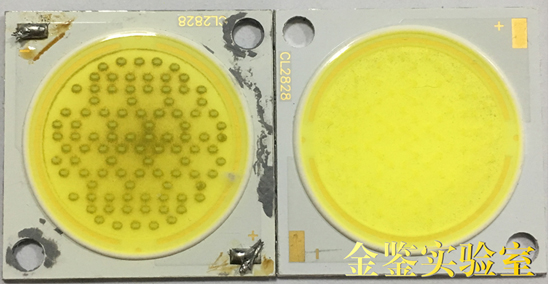
COB光源外观图
金鉴工程师利用激光开封COB光源,在光学显微镜下观察COB光源内部芯片和键合线情况。COB光源激光开封后,内部完好无损,芯片和线材完整无损,利于做进一步的失效分析。

COB光源激光开封后,芯片和线材完整无损
案例五:激光开封LED灯珠硅胶封装样品。
客户送测灯珠样品来做芯片厂家鉴定,金鉴工程师利用激光开封样品后做SEM观察+尺寸测量等芯片厂家来源鉴定测试分析
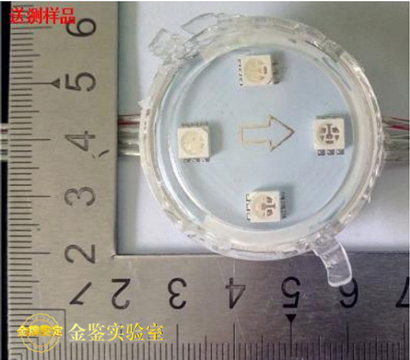
客户送测样品
金鉴工程师利用激光开封客户送测LED硅胶样品:
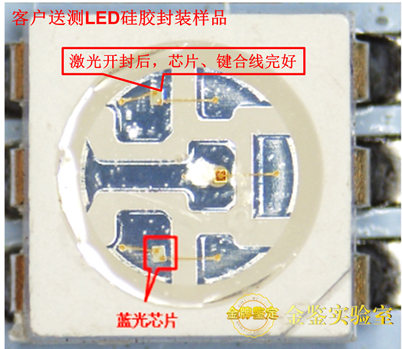
LED灯珠激光开封后芯片和键合线完好
金鉴工程师利用SEM观察开封后灯珠芯片并进行尺寸测量分析:
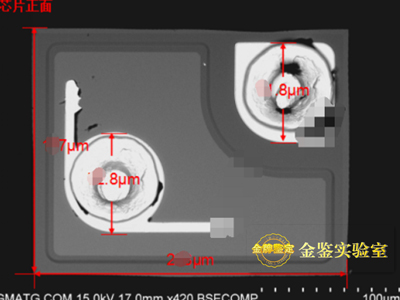
LED灯珠开封后芯片尺寸测量
- 上一篇: AEC-Q102自动光电测试机
- 下一篇: 金鉴EMMI(微光显微镜)
















