碳化硅MOSFET栅极氧化层缺陷的检测技术 发布时间:2024-12-06
碳化硅材料在功率器件中的优势
碳化硅(SiC)作为第三代化合物半导体材料,相较于传统硅基器件,展现出了卓越的性能。SiC具有高禁带宽度、高热导率、高的击穿电压以及高功率密度特性。这些特性使得SiC器件在高效电能转换应用领域具有不可替代的优势,正逐渐成为功率半导体领域的主流选择。金鉴实验室作为专业的检测机构,能够为SiC材料的性能评估提供全面的测试服务,确保材料的质量和可靠性,为客户的产品设计提供有力支持。
碳化硅器件的技术挑战
尽管SiC器件性能优越,但其单晶和外延材料价格较高,工艺不成熟,导致技术难度较大。SiC器件制作的技术难度之一就是栅氧交界面容易受到外在缺陷的影响,这些缺陷可能源自外延或衬底缺陷、金属残留、粉尘颗粒,或其它制造过程中引入的外来杂质。
栅极氧化层缺陷的影响
外在的缺陷主要是栅极氧化层的变形,导致局部氧化层变薄,增加了器件早期失效的风险。这些缺陷可能源自于EPI或衬底缺陷、金属杂质、颗粒,或在器件制造过程中掺入到栅极氧化层中的其他外来杂质。金鉴实验室在失效分析方面拥有丰富的经验和专业的技术手段,能够诊断栅极氧化层缺陷的原因和影响。
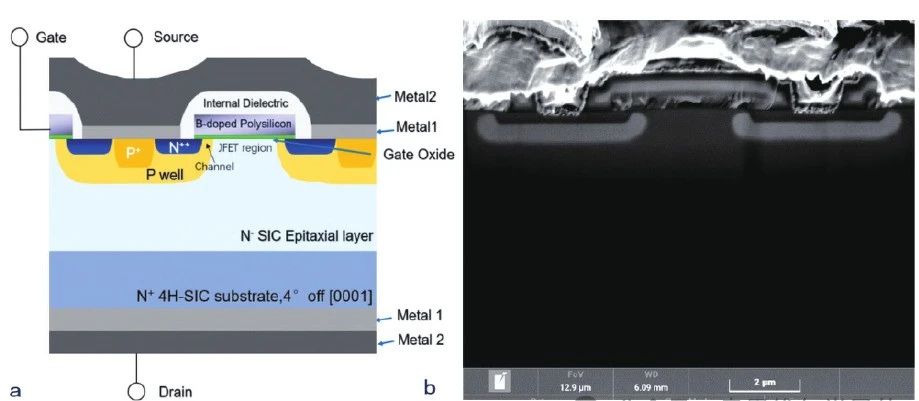
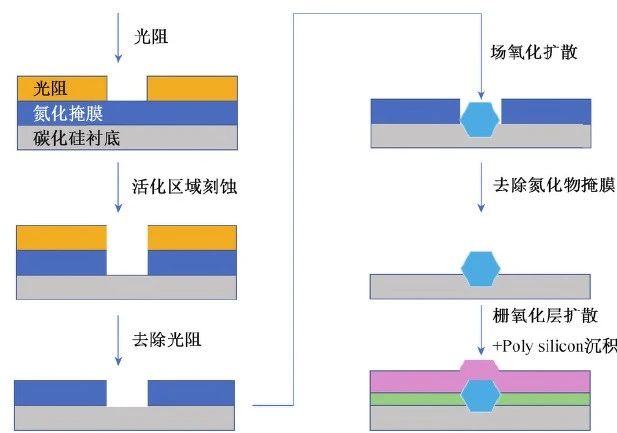
SiC MOSFET检测基本原理
SiC MOSFET器件的基本结构中,栅极氧化层的漏电与质量关系极大,漏电增加到一定程度即构成击穿,导致器件失效。因此,对栅极氧化层缺陷的研究以促进工艺改善和设计优化极为重要。金鉴实验室在漏电检测和质量评估方面具备专业的技术团队,能够为客户提供高效、准确的检测服务,助力器件的优化设计。
加速筛选实验
为了改善栅极氧化层的质量,研究者们进行了包括NO退火钝化、氮磷同步混合钝化以及碱土金属氧化物钝化等多种钝化方法的研究。此外,通过高温栅偏实验(HTGB)等加速寿命实验,可以考察待测样品的特性退化。金鉴实验室能够开展多种加速筛选实验,为客户提供全面的实验数据支持,帮助其在材料研发和工艺改进中做出科学决策。
故障定位和失效分析
在加速筛选实验后,对缺陷品进行故障定位和失效分析至关重要。金鉴实验室凭借其先进的分析设备和专业技术,能够精准定位缺陷位置,深入分析失效原因。通过对应力筛选实验的缺陷品进行故障定位和失效分析,利用聚焦离子束和成分分析方法验证了栅极氧化层物理损伤点。这对于SiC MOSFET的早期失效研究有着重要参考作用。
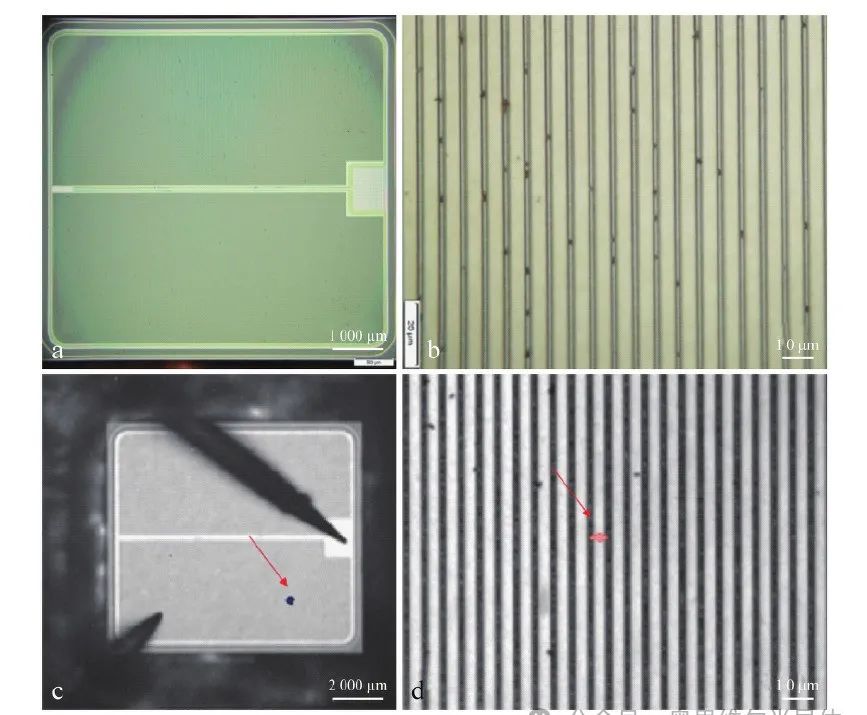
结论
本文提出的SiC MOSFET器件栅氧化层缺陷的检测方法,通过HTGB应力筛选实验和缺陷检测,以及对失效样品的故障定位和失效分析,有效地拦截了SiC MOSFET的栅氧化层缺陷。这对于碳化硅器件的早期失效分析研究具有重要意义,可以为SiC MOSFET器件设计和制程改善提供科学、客观的依据。金鉴实验室在这一领域的专业检测服务,将为客户的SiC器件研发和生产提供强有力的技术支持。
- 上一篇: 功率半导体模块的可靠性评估:功率循环测试研究
- 下一篇: 金属材质化学组成与标准分析技术





