离子束制样条件对TEM样品形貌的影响 发布时间:2024-08-28
半导体技术
集成电路产业的持续发展带来了半导体制程技术的不断进步。随着线宽的缩小,晶体管体积减小,使得在相同面积上能够集成更多的电路,从而提升了芯片的性能。然而,线宽的减小也带来了挑战,如线路短路或开路的缺陷尺寸更小,良率的提升变得更加困难。透射电子显微镜(TEM)因其高分辨率和精确度,在半导体集成电路失效分析领域扮演着重要角色。一下是制备步骤:

在制备TEM样品时,聚焦离子束(FIB)技术因其定位准确、切割精度高、制样速度快和成功率高而广泛应用。为了方便对材料进行深入的失效分析及研究,金鉴实验室具备Dual Beam FIB-SEM业务,包括透射电镜( TEM)样品制备,材料微观截面截取与观察、样品微观刻蚀与沉积以及材料三维成像及分析等。
FIB制样过程中,离子束能量、离子束电流、刻蚀时间等参数共同决定了刻蚀的形状和深度。然而,不当的制样条件可能会引入人工缺陷,影响TEM分析结果的准确性。
实验与分析
通过实验分析了FIB制样条件对TEM样品形貌的影响,包括制造工艺、离子束切削参数、保护层沉积条件等。研究发现,离子注入工艺和FIB制样条件可能共同作用导致样品缺陷。
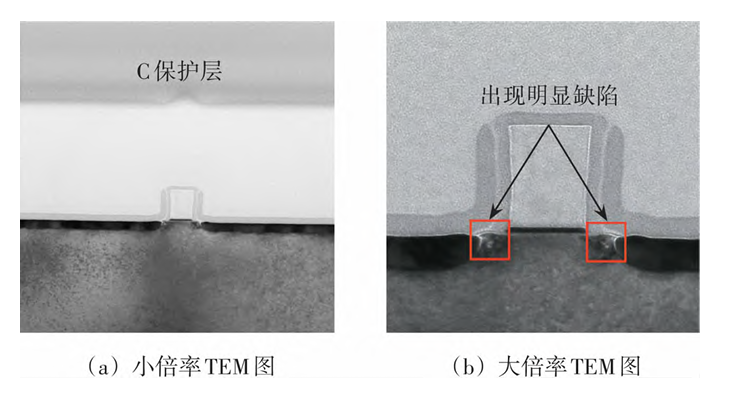
FIB切削能量并非引起样品表面缺陷的主要原因,而电子束辅助沉积保护层的条件对样品表面形貌有显著影响。通过优化电子束能量参数,并使用原子质量较大的材料作为保护层,可以有效减少由热损伤引起的缺陷。

FIB常规条件制备样品的TEM图
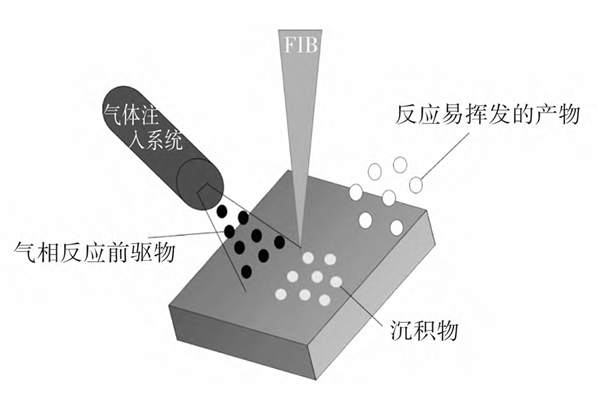
FIB系统辅助沉积保护层原理图
这些发现对于优化FIB制样条件、提高TEM样品质量、降低产品缺陷率以及提升集成电路制造过程中的良率具有重要意义。通过深入理解FIB制样条件对样品形貌的影响,可以为失效分析提供更准确的数据支持,进一步推动集成电路产业的发展。
- 上一篇: AEC-Q102 温度循环试验
- 下一篇: EBSD在晶粒度测量中的分析和应用





