元器件筛选 发布时间:2023-10-24 10:05:38
电子元器件是指用于电子设备中进行电能、信号传输、控制调节或转换的基础器件,在电子通信、信息处理和自动控制等领域起到不可或缺的作用,如果把整机比作人的身体,元器件相当于身体中的细胞,各司其职,维持整个产品的运行。
为了保证装机的元器件在其全寿命阶段均能有效工作,避免个别器件由于本身固有的缺陷或制造工艺的差异性导致的早期失效对整机工作状态的影响,必须根据应用环境选择试验类型和条件对元器件进行筛选,剔除可能出现早期失效的器件。
一、可靠性筛选分为一次筛选、二次筛选、补充筛选、特定筛选和批次评价,简单来说:
一次筛选是制造商按照规范和标准要求进行;
二次筛选是为了控制电子元器件的质量,在其投入使用前再次进行检验,是由用户进行的筛选工作;
补充筛选是使用方有特殊要求,委托相关单位或制造商再次进行的筛选,特定筛选主要是针对一些有质量要求的电子元器件开展的特定评价试验;
批次评价是对同一批电子元器件进行抽样试验,以此分析该批次元器件整体质量可靠性。
二、本文主要针对常规筛选程序的设计思路和方向
1.方案设计第一步:确定元器件潜在易失效模式
元器件失效模式主要考虑封装失效和电性能失效,封装失效可以通过对器件施加环境因素使各种潜在缺陷加速为早期故障然后进行排除,使交付产品可靠性指标满足设计指标的要求。
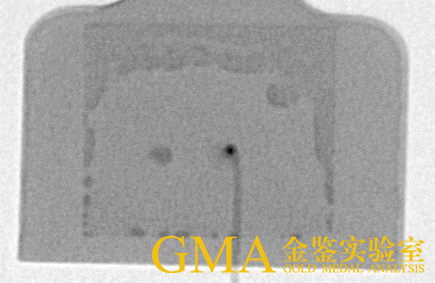
图1 封装失效(接触区空洞超过接触面积的1/2)
电性能失效可以分为连接性失效、功能性失效和电参数失效,连接性失效指开路、短路以及电阻值大小的变化,主要失效模式为元器封装涂覆发生锈蚀、外壳断裂、引线熔断、脱落或者与其他引线发生短路,作用到产品上表现出由于机械或热应力损伤导致的金属疲劳、键合强度不符合标准要求等情况。
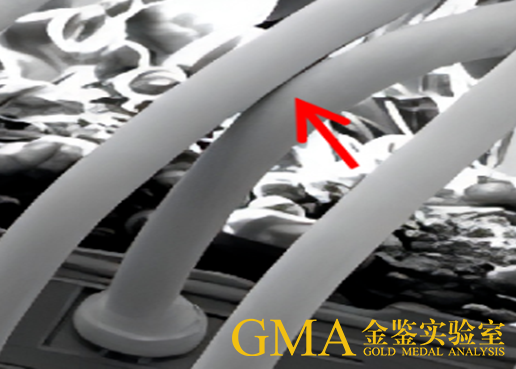
图2 连接性失效(键合丝之间接触)
功能性失效和电参数失效主要表现为特定的功能丧失或参数超差,主要失效机理是由于在制造、设计中存在缺陷,生产工艺中控制不足(空气洁净度、超纯水的质量检测、化学试剂、模具公差、设备维护等方面),甚至在转运过程中由于防静电措施不当也会出现静电损伤。

图3 工艺控制不足导致多余物存在于器件内部
2.方案设计第二步:针对易失效模式选择合适的试验类型
根据GJB7243-2011《军用电子元器件筛选技术要求》的内容典型的可靠性筛选项目如下:
①高温贮存
电阻元器件的失效大多数是由于体内和表面的各种物理化学受温度环境变化引起的,随着温度升高其化学反应速度加快,加速表面玷污、键合不良、氧化层缺陷等失效情况的出现,并予以剔除。同时经过高温贮存后的元器件可以参考封装后固化的机理使器件的参数性能稳定,减少使用过程中的参数漂移。但是在条件选择时需参考器件的工作温度和贮存温度等因素,避免由于过温或时间过长产生新的失效机理。
②电老炼
在电应力和热应力的作用下,可以模拟实际工作情况,暴露出元器件内部和表面的多种潜在缺陷,通常情况下,器件在其额定功率的条件下进行8小时到240小时甚至更长周期的试验(取决于使用环境和应用领域)。
③温度循环
针对产品在使用环境中遇到高低温交替的条件,在热胀冷缩的应力作用下,膨胀系数匹配性较差的元器件易出现金属疲劳的微裂、焊点疲劳、框架的分层等失效现象。
④恒定加速度
目的是考核电路承受X/Y/Z/X-/Y-/Z-六个方向的离心力的能力,可以暴露由器件结构强度低或固有的机械缺陷引起的失效情况,如芯片脱落、内引线开路、框架变形、漏气等。
⑤粒子碰撞噪声检测
主要目的是检验微电路空腔封装体内是否存在可动多余物,多余物可能导致元器件内部短路失效,试验原理是对器件施加适当的机械冲击应力使粘附在期间腔体内的多余物变为可动多余物,在同时施加振动应力,使可动多余物产生振动与腔体撞击产生噪声。
⑥密封检验
主要应用于具有空腔的电子元器件封装的气密性试验,包括粗检漏和细检漏。细检漏可以通过氦质谱检漏法、放射性同位素Kr85和光干涉法实现对小通道的泄露实现检验,粗检漏采用各种溶液的气泡法(硅油、氟化物、酒精、浸润水溶液等)、称重法、染色法等实现对大通道泄露的检测。
⑦ X-ray检验
利用高电压撞击靶材产生X射线穿透来检测半导体内部结构质量,框架是否有剥离、开裂、空洞或键合不良的情况,是一种常用的无损检验方式。
⑧ C模式扫描声学显微镜超声检测
通过超声波与不同密度材料的反射速率及能量不同的特性来进行分析,利用纯水当介质传输超声波信号,当信号遇到不同材料的界面时会部分反射或穿透,回波强度会因为材料密度不同而产生差异。利用上述特性可无损检测元器件是否存在分层、裂纹、空洞等缺陷,并通过图像对比度判别材料内部声阻抗差异性,确定缺陷形状、尺寸和位置。
3.方案设计第三步:根据筛选原则确定最终试验方案
①应根据被测器件的潜在失效模式定义其可承受的试验条件;
②应了解器件的电特性、材料属性和封装工艺,并结合特点指定试验条件;
③失效概率较大的试验优先进行;
④当一种失效模式与其他失效模式产生关联时,应将容易造成此失效的试验优先进行;
⑤使用不同方法对同一种失效模式进行筛选时,根据失效概率的分布,对容易触发失效的试验优先进行;
⑥考虑经济性和实效性,将成本低和时间短的试验优先进行。
电子元器件的固有可靠性取决于产品的可靠性设计,在制造过程中,由于人为因素、工艺水平、设备条件导致成品不能达到固有可靠性的预期,因此在电子元器件装机之前,把早期失效的产品筛选剔除是保证整机可靠性的重要手段。
针对上述提到的筛选试验程序,金鉴实验室建立了元器件筛选的试验线,典型设备图所示:

- 上一篇: LED灯具可靠性试验方法(GB/T 33721-2017)
- 下一篇: AEC-Q102测试认证






