芯片漏电点定位及分析(EMMI/OBIRCH,显微光热分布,FIB-SEM) 发布时间:2025-02-12 09:41:46
1.设备原理
.EMMI
微光显微镜(Emission Microscope, EMMI)是利用高增益相机/探测器来检测由某些半导体器件缺陷/失效发出的微量光子的一种设备。金鉴实验室凭借其先进的EMMI设备,能够精准捕捉半导体器件缺陷/失效发出的微量光子。在对样品施加适当电压后,实验室的专业技术人员会利用高增益相机/探测器,收集信号图和背景图,通过专业的图像处理技术,将两者叠加,从而快速、准确地定位发光点的位置,锁定失效点。这种技术在金鉴实验室的日常检测工作中发挥着重要作用,为众多半导体企业提供失效分析的关键线索。
原理:当对样品施加适当电压时,其失效点会因加速载流子散射或电子-空穴对的复合而释放特定波长的光子。这些光子经过收集和图像处理后,就可以得到一张信号图。撤去对样品施加的电压后,再收集一张背景图,把信号图和背景图叠加之后,就可以定位发光点的位置,从而实现对失效点的定位。
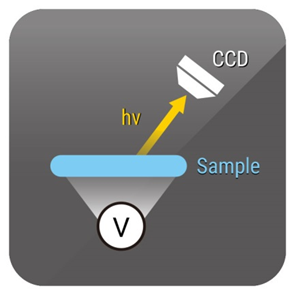
.OBIRCH
光诱导电阻变化(Optical Beam Induced Resistance Change,OBIRCH),作为一种新型的高分辨率微观缺陷定位技术,能够在大范围内迅速准确地进行器件失效缺陷定位,基本上,只要有芯片异常的漏电,它都可以产生亮点出来。
原理:用激光束在通电恒压下的芯片表面进行扫描,激光束部分能量转化为热能,如果芯片存在缺陷点,缺陷处温度将无法迅速通过金属线传导散开,这将导致缺陷处温度累计升高,并进一步引起金属线电阻以及电流变化,通过变化区域与激光束扫描位置的对应,定位缺陷/失效位置。该方法常用于芯片内部高阻抗及低阻抗分析,芯片漏电路径分析。
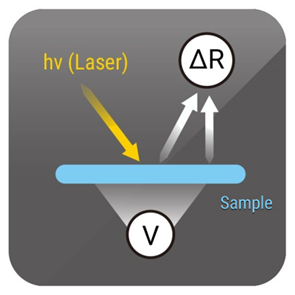
.显微光热分布测试系统
用于测量光源的光强分布、直径、发散角和观察芯片光热分布、甚至电流扩散分布情况等参数。
显微光分布测试系统原理:金鉴实验室联合英国GMATG公司联合推出显微光分布测试系统,主要用于测试光源的发光均匀性,帮助提高光品质。现已演化到第五代,而且价格从150万降到几十万!金鉴显微光分布测试系统针对LED及其他光电器件产业打造,可用于观察微米级发光器件的光分布,测试波长范围190nm ~1100nm,包含了紫外和红外不可见光的测试,可用于测量光源的光强分布、直径、发散角等参数。通过CCD测量光强分布,通过算法计算出光源直径等参数,测量光强的相对强度,不需要使用标准灯进行校准。适合光电器件及照明相关领域的来料检验、研发设计和客诉处理等过程,以达到企业节省研发和品质支出的目的。
显微热分布测试系统原理:金鉴显微红外热分布测试系统(GMATG-G5)由金鉴实验室和英国GMATG公司联合推出,采用法国的非晶硅红外ULIS探测器,通过算法、芯片和图像传感技术的改进,打造出一套高精智能化的显微红外热分布测试体系。这套测试体系专为微观热成像设计,价格远低于国外同类产品,除传统红外热成像的优势外,还具有更高精度的成像系统、更高的温度灵敏度,更便捷的操作体系,并为微观热成像研究添加诸多实用和创新的功能,是关注微观热分布的科研和生产必不可少工具。
.FIB-SEM
聚焦离子束(Focused Ion beam,FIB)与扫描电子显微镜(Scanning Electron Microscope,SEM)耦合成为FIB-SEM双束系统后,通过结合相应的气体沉积装置,纳米操纵仪,各种探测器及可控的样品台等附件成为一个集微区成像、加工、分析、操纵于一体的分析仪器。其应用范围也已经从半导体行业拓展至材料科学、生命科学和地质学等众多领域。
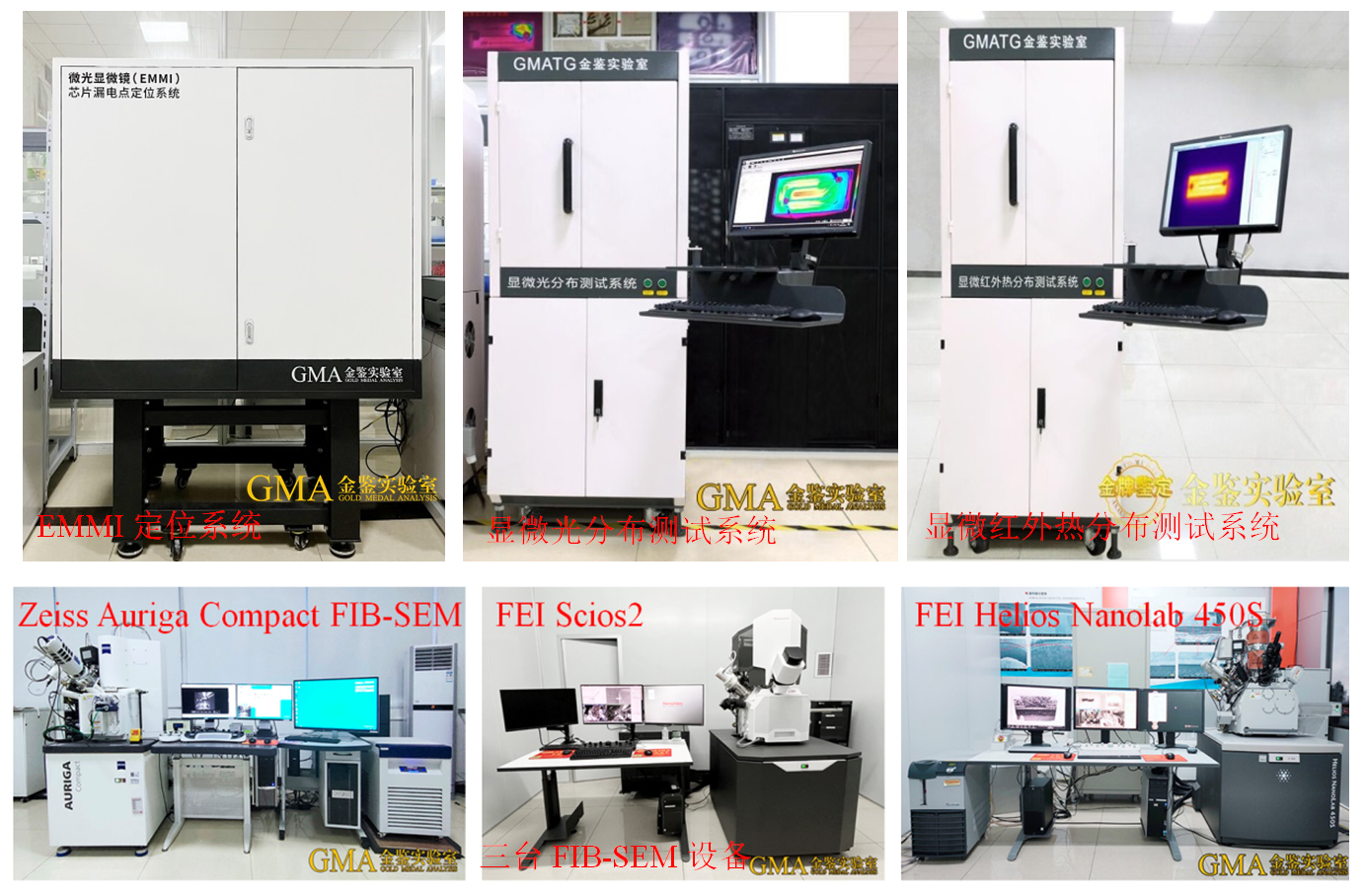
金鉴芯片漏电点定位及分析设备群
2.解决方案
鉴于以上设备各自的特点,金鉴实验室有机地整合了上述所有的测试设备,形成了完备的芯片漏电点定位及分析设备群,推出了一套完整的芯片漏电点定位及失效分析解决方案,为半导体产业健康向上发展保驾护航。
首先,我们通过自研的EMMI定位系统定位漏电点,对于漏电流较小的,可以通过分辨率更高的OBIRCH定位漏电点。其次,作为补充,当EMMI/OBIRCH均不能定位漏电点时,我们还可以通过自研的显微光热分布测试系统测试芯片的光分布和热分布,光分布/热分布的异常位置即为芯片漏电的位置,从而定位漏电点。最后,通过FIB对漏电点精确切片,接着进行SEM表征测试,以便分析漏电原因。
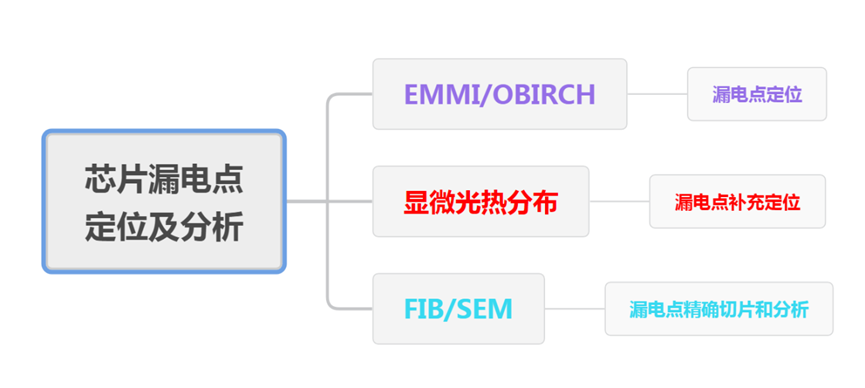
3.案例分析:
客户送测红光LED死灯样品,要求分析失效原因。初步进行电性测试后,确定为芯片漏电所致,因此,对芯片进行漏电点定位和分析。
(1) 首先取NG1、NG2样品进行EMMI测试,结果如下:
对NG1进行EMMI漏电点定位,漏电位置在芯片焊球的一侧,位置靠近引线一侧,如下图所示。

(2) 由于对NG2样品进行EMMI和OBIRCH测试,均未能定位漏电点,因此对NG2进行显微光热分布定位测试,测试结果如下:
对NG2进行光热漏电点定位,漏电位置在芯片焊球的一侧,位置靠近引线一侧,如下图所示。

对NG2和OK1样品进行光热分布对比测试,进一步地印证漏电点位置在芯片焊球的一侧,位置靠近引线一侧,如下图所示。
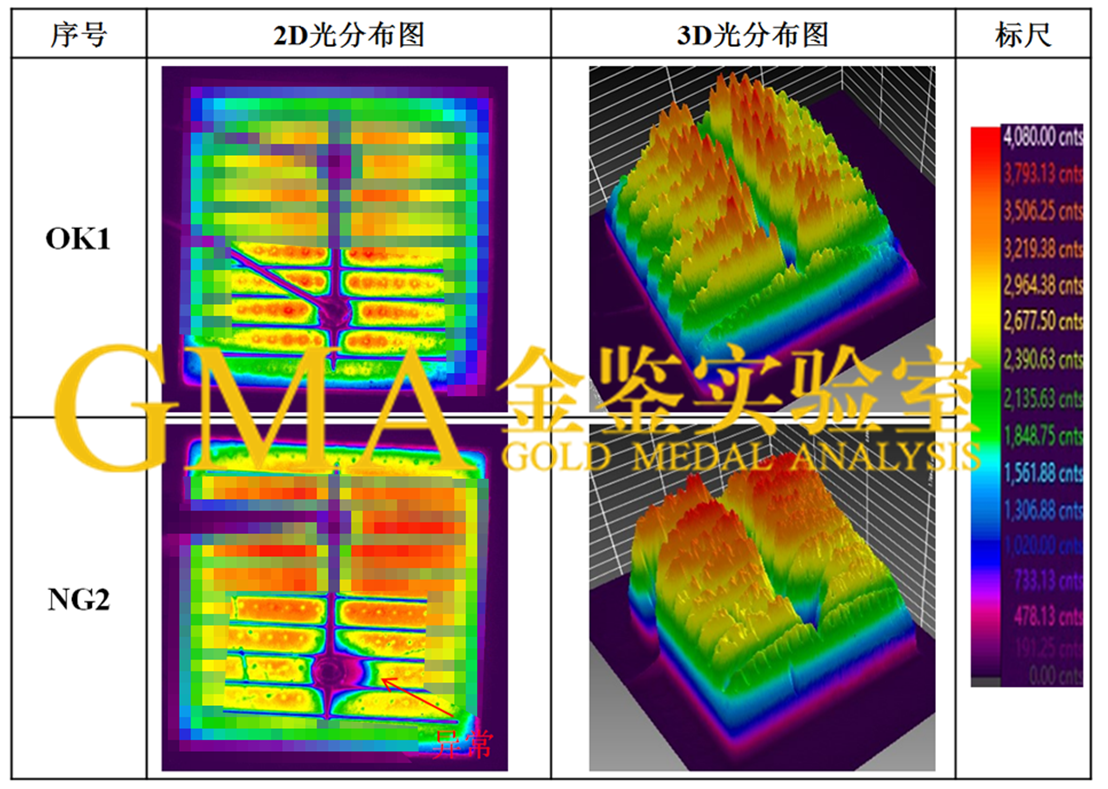
光分布测试对比图

热分布测试对比图
(3)对芯片漏电点定位后,通过FIB对漏电点精确切片,接着进行SEM表征测试,分析漏电原因,测试结果如下:
对NG1漏电位置进行FIB-SEM截面分析,可观察到芯片外延出现断裂异常。芯片外延断裂会导致外延PN结错位,从而引起芯片出现漏电或者短路失效。
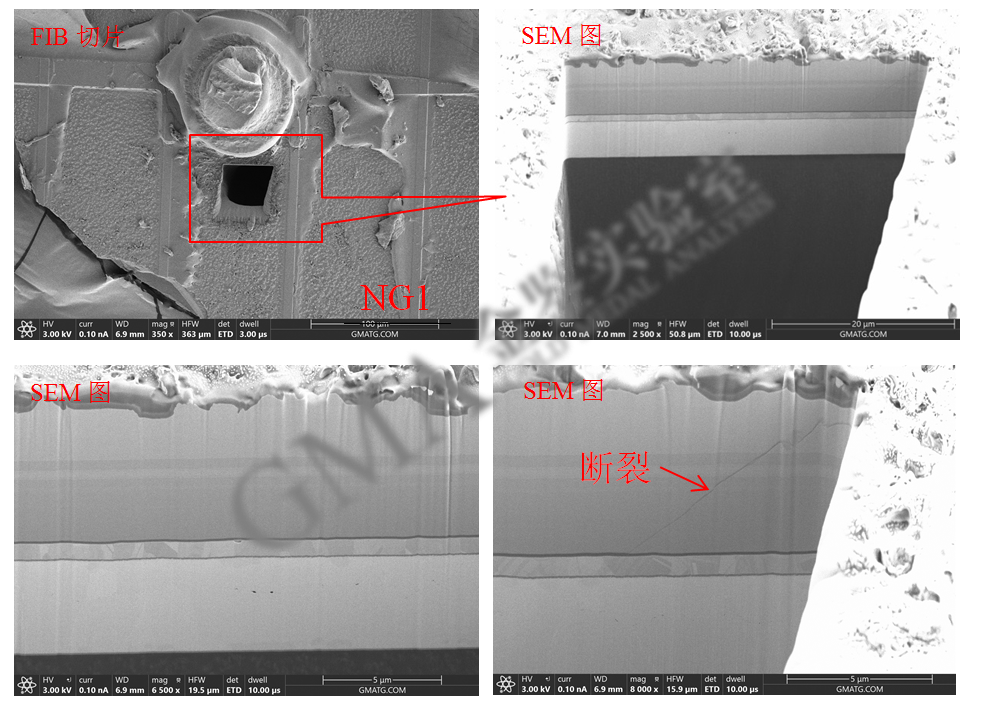
对NG2漏电位置进行FIB截面分析,可观察到芯片外延出现断裂异常。芯片外延断裂会导致外延PN结错位,从而引起芯片出现漏电或者短路失效。
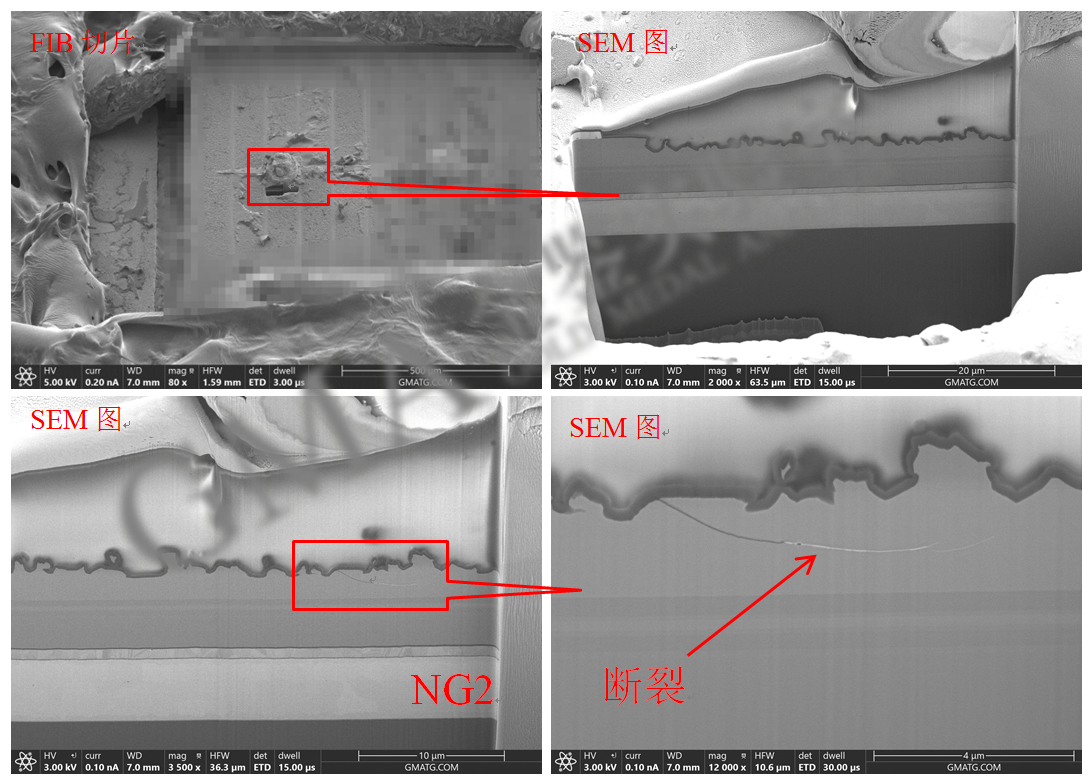
综上所述,送测LED灯具红光失效的原因是芯片焊球位置外延开裂,造成芯片漏电或者短路失效。此案例也较好地论证了我们金鉴实验室的芯片漏电点定位及分析设备群的完备性及解决方案的可行性。在实际工作中,金鉴实验室经常遇到各种复杂的芯片失效问题,但凭借其专业的技术实力和严谨的工作态度,总能够为客户找到准确的答案,为半导体产业的健康发展保驾护航。
- 上一篇: LED芯片横截面解析(FIB+SEM)
- 下一篇: LED外延片结构SIMS解析






