金鉴显微红外热像仪在功率器件产业的应用-芯片微观热态研究 发布时间:2021-06-09
金鉴显微红外热像仪是一种以非接触的形式测量样品表面温度和温度分布的无损检测分析仪器,根据热分布的异常区或异常点,暴露不合理的设计和工艺缺陷,可研究器件因设计、材料、工艺缺陷通过热效应所造成的温度分布不匀、局部热斑等失效。因而它能更有效地、直接地用于电子元器件、微组装件的热性能检测和热失效分析,主要用于分析功率器件和混合集成电路。通常可应用于以下方面:
一产品的热设计验证
一热阻测量(稳态、瞬态热阻)
一峰值结温的测量
一热耗散功率分析
一稳态、瞬态热性能分析,
一芯片、基板粘接性能分析
一电路内部通断分析
一由于晶体缺陷、杂质和静电放电引起的漏电通道
一电路的门锁通道
一检测划伤处或氧化层台阶处金属化图形的收缩所引起的局部发热
一检测双层布线互连孔的局部发热
一检测由大电流引起的内引线过分发热或内引线键合性能分析
一检测芯片裂缝
本文以金鉴自研发的显微红外定位系统来定位漏电失效的SiC MOSFET芯片,并与OBIRCH对比定位效果,然后用FIB做定点截面切割,观察到金属化薄膜铝条被熔断。
案例分析:
据客户反馈,应用于新能源汽车SiC MOSFET器件芯片部分出现电学失效现象:共16个器件,其中5个正常,11个失效。其中失效情况:芯片漏电,及部分芯片烧毁,送测样品图如下:
金鉴工程师随机抽取其中一个漏电失效MOS管器件芯片样品进行初步漏电失效分析。
测试样品发射率,更精准测温:
调整芯片发射率后利用金鉴显微红外热点定位测试系统测得样品热点温度为70 ℃,图中A点温度为56 ℃。

测试原理:精密半导体器件存在缺陷异常或性能不佳的情况下,通常会表现出异常局部功耗分布,最终会导致局部温度升高。金鉴显微红外热点定位系统利用新型高分辨率微观缺陷定位技术进行热点锁定(lock in) ,可快速而准确地探测细微缺陷(异常点)位置。
OBIRCH在显示SiC芯片漏电点上的效果一样,但是价格却大大降低。


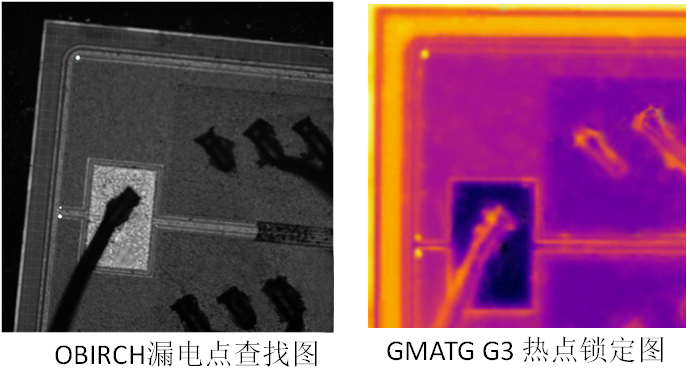
对热点进行FIB切割分析:
我们观察到此发热点金属化薄膜铝条被熔断。
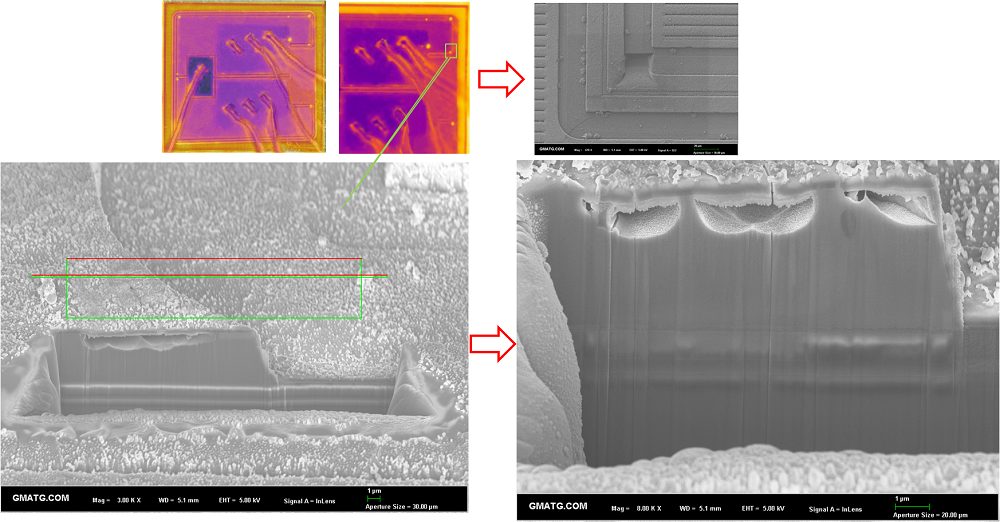
存在缺陷或性能不佳的半导体器件通常会表现出异常的局部功耗分布,最终会导致局部温度增高。金鉴显微红外热点定位测试系统利用热点锁定技术,可准确而高效地确定这些关注区域的位置。在SiC Mos等功率器件分析中,可用来确定线路短路、ESD击穿等。该测试技术是在自然周围环境下执行的,无需液氮制冷和遮光箱。
- 上一篇: 如何科学测试IGBT器件结壳热阻值?
- 下一篇:






